前(qian)言
磁控溅射镀(du)膜(mo)属于(yu)物理气相沉(chen)积(ji),离子(zi)在电(dian)场(chang)加速(su)下高速轰击(ji)阴极(ji)靶(ba)材,靶(ba)材原子被(bei)溅射出来(lai)后沉积(ji)到被镀(du)膜体(ti)表(biao)面而(er)形成(cheng)薄(bao)膜����,是用来制(zhi)备薄膜(mo)材料的(de)一(yi)种主要方(fang)法(fa)[1]。它的基本(ben)原理(li)是:真(zhen)空(kong)环(huan)境中电(dian)场加速离子(zi)后(hou)形成(cheng)具(ju)有高动(dong)能(neng)的离(li)子(zi)束流,碰撞固(gu)体(ti)表面(mian)���,固(gu)体(ti)表面的(de)原子被(bei)溅射(she)出(chu)并离开固体沉(chen)积在(zai)被(bei)镀膜(mo)体表(biao)面(mian)�����,被离子(zi)高速碰(peng)撞(zhuang)的固(gu)体就是产(chan)生(sheng)薄(bao)膜的(de)来源���,被称(cheng)之(zhi)为溅射(she)靶材(cai)[2]����。溅射(she)法(fa)是(shi)一种(zhong)先进(jin)的薄(bao)膜(mo)材(cai)料(liao)制(zhi)备(bei)技(ji)术�����,这种(zhong)方(fang)法(fa)具有(you)速度(du)高和温度低(di)两大特(te)点[3]����。自20 世(shi)纪80 年(nian)代(dai)�����,信息存储、集成电路(lu)、激光(guang)存(cun)储器���、液晶(jing)显(xian)示(shi)器����、电子(zi)控(kong)制(zhi)器(qi)等(deng)产业开始进入高(gao)速(su)发(fa)展(zhan)时(shi)期(qi),磁控溅(jian)射(she)技(ji)术才(cai)从实(shi)验室真正进入(ru)工(gong)业化(hua)规(gui)模(mo)生(sheng)产(chan)[4]。我(wo)国(guo)已经(jing)逐渐(jian)成为(wei)薄(bao)膜靶材(cai)需(xu)求大国,在(zai)全球(qiu)市(shi)场(chang)需(xu)求的(de)拉(la)动(dong)下(xia)�,
我(wo)国(guo)有很多材料领域的科研(yan)院(yuan)所(suo)及企(qi)业���,开展(zhan)了溅(jian)射(she)靶材的研发(fa)和生产(chan)工作(zuo),并取得了很大的(de)进展。
难(nan)熔金属,一(yi)般包括(kuo)钨(wu)、钽(tan)��、钼(mu)���、铌(ni)、铪(ha)�、锆和(he)钛,其熔(rong)点(dian)都(dou)在(zai)1 600 益以(yi)上。钨(wu)、钼等合金材(cai)料(liao)高(gao)温强度和蠕变(bian)性能(neng)好(hao),被(bei)广(guang)泛用于(yu)微(wei)电(dian)子(zi)��,照明(ming)光(guang)源(yuan)����、武(wu)器(qi)系(xi)统�、原(yuan)子(zi)能(neng)等(deng)行(xing)业(ye)。钽(tan)铌(ni)极(ji)其合(he)金(jin)具有(you)较低蒸(zheng)气(qi)压(ya)、低热(re)膨(peng)胀(zhang)系(xi)数、优秀(xiu)的(de)抗(kang)腐蚀(shi)性能,被广(guang)泛用于(yu)航空(kong)航(hang)天(tian)�、化工装(zhuang)备(bei)���、集成(cheng)电(dian)路、核能(neng)部门[5]。将(jiang)难(nan)熔金(jin)属制作成靶(ba)材(cai)可将其(qi)优(you)秀(xiu)性能(neng)以(yi)薄(bao)膜的(de)形(xing)式(shi)利用�。表(biao)1给(gei)出(chu)了(le)几(ji)种难(nan)熔(rong)金属(shu)靶(ba)材的(de)应用领域����。

1��、难熔(rong)金属(shu)靶(ba)材的(de)类型(xing)及应用(yong)
溅(jian)射(she)用(yong)靶材(cai)有如(ru)下(xia)几(ji)种分类(lei)方(fang)法(fa):如(ru)按材质(zhi)分靶(ba)材(cai)可分(fen)为(wei)金(jin)属靶、高(gao)分子(zi)陶瓷非金属靶和复(fu)合材(cai)料靶等�。如(ru)按(an)外(wai)形(xing)尺(chi)寸可(ke)分为(wei)圆柱形�����、长方(fang)形、正(zheng)方(fang)形(xing)板(ban)靶(ba)和管(guan)靶(ba),见图1��。

因为一般(ban)常(chang)见的方(fang)靶(ba)圆靶(ba)都为实(shi)心(xin)�,在(zai)镀(du)膜(mo)作(zuo)业中,圆(yuan)环形的永磁体(ti)在(zai)靶的(de)表面产(chan)生(sheng)的磁(ci)场(chang)为环(huan)形(xing),会发(fa)生(sheng)不(bu)均(jun)匀冲蚀现象(xiang),溅(jian)射(she)的薄膜(mo)厚度均(jun)匀性不(bu)佳,靶材的使(shi)用效(xiao)率(lv)大(da)约(yue)只有20 %~30 %��。而目(mu)前(qian)被推广(guang)的(de)空(kong)心(xin)管靶可(ke)绕固(gu)定(ding)的(de)条状(zhuang)磁(ci)铁(tie)组(zu)件(jian)一(yi)定周(zhou)期旋转(zhuan)运(yun)动,360毅(yi)靶面可(ke)被(bei)均匀刻(ke)蚀(shi)���,优(you)势明(ming)显(xian)�,将利用(yong)率(lv)提高到80 %[6]����。
1.1 钨(wu)靶
钨(wu)是难(nan)熔金(jin)属(shu)熔(rong)点(dian)最(zui)高(gao)的(de)一(yi)种���,具(ju)有(you)稳定的(de)高(gao)温特(te)性(xing)、抗电(dian)子(zi)迁移能(neng)力和较(jiao)高的电子(zi)发射系(xi)数(shu)等诸多优点(dian)。钨(wu)及钨合(he)金靶(ba)在微(wei)电(dian)子(zi)、集成电(dian)路(lu)等(deng)行业中(zhong)被大量使(shi)用(yong)。Al、Cu,Ag 目前是(shi)集(ji)成电(dian)路制造(zao)用(yong)得(de)最多(duo)的(de)互(hu)连(lian)线(xian)材(cai)料(liao)���,一般来(lai)说(shuo)介(jie)质(zhi)层(ceng)是(shi)Si 或SiO2,Al�����、Cu��,Ag 会(hui)向介(jie)质(zhi)中(zhong)扩(kuo)散(san)而形成硅化(hua)物,从(cong)而使金(jin)属(shu)连线(xian)的(de)电流强(qiang)度急(ji)剧变(bian)弱(ruo)���,整个布(bu)线系统(tong)功能可能(neng)会因(yin)此(ci)而(er)崩(beng)溃。最(zui)好的解(jie)决(jue)方案是(shi)在(zai)布线(xian)与(yu)介质之(zhi)间再进行(xing)屏(ping)蔽来(lai)阻挡扩(kuo)散层,阻挡(dang)层(ceng)金属是(shi)WTi。
大量试验证(zheng)明�����,WTi 合金(jin)(Ti 占(zhan)10 %~30 %)作为阻挡层已被(bei)成功地应(ying)用(yong)于Al����、Cu 和(he)Ag 布线技(ji)术。由(you)于金属W在其(qi)他(ta)金属(shu)中(zhong)原子(zi)的扩(kuo)散率较低�,可(ke)阻挡扩(kuo)散(san),Ti 可(ke)有效(xiao)地(di)阻止(zhi)晶(jing)界(jie)扩散(san),另(ling)一方面(mian)也提(ti)高了(le)阻挡层(ceng)的(de)黏(nian)结力和抗(kang)腐(fu)蚀性(xing)能(neng)[7-8]����。
钨(wu)靶(ba)还(hai)被(bei)应用于装饰镀(du)膜行业(ye)��,如(ru)手表(biao)、眼镜、卫生(sheng)洁(jie)具(ju)、五(wu)金零(ling)件(jian)等(deng)产品,不仅(jin)能美(mei)化外观(guan)��,同(tong)时(shi)也(ye)具(ju)有(you)抗磨(mo)损、腐(fu)蚀等功(gong)能�。近些年(nian)来装饰(shi)镀膜(mo)用靶(ba)材(cai)的(de)需(xu)求(qiu)量(liang)日(ri)益(yi)扩(kuo)大[9]。国内(nei)研(yan)发W靶材的(de)主要(yao)单位(wei)有(you)上海钢铁(tie)研究所����、北京安泰科技(ji)����、西(xi)北(bei)有色金(jin)属(shu)研究院(yuan)、株(zhu)洲硬(ying)质(zhi)合金(jin)集团(tuan)等。
1.2 钼(mu)靶(ba)
钼具有(you)高(gao)熔点、较低(di)的(de)比阻抗、高(gao)电(dian)导率(lv)�、较(jiao)好的耐腐蚀性(xing)而(er)被广(guang)泛(fan)用(yong)于(yu)LCD显(xian)示(shi)屏(ping)����、光伏(fu)电池(chi)中的配(pei)线(xian)、电极。还有(you)集(ji)成电(dian)路的(de)阻挡(dang)层材(cai)料����。
金属Cr 曾是(shi)LCD 显示(shi)屏(ping)配(pei)线的首(shou)选(xuan)材料(liao),如(ru)今(jin)超大(da)型�����、高精度LCD 显(xian)示屏发展迅(xun)速,这对材(cai)料的(de)比阻抗(kang)提出了(le)更(geng)高(gao)的要求��。此(ci)外(wai),环境(jing)保护(hu)也(ye)必(bi)须(xu)兼(jian)顾(gu)��。金属Mo 的膜应(ying)力(li)的(de)比阻(zu)抗只有(you)铬(ge)的(de)一(yi)半�����,且(qie)不会(hui)污染(ran)环境(jing),诸(zhu)多优(you)势使(shi)金(jin)属(shu)Mo 成为LCD 显示(shi)屏溅(jian)射靶(ba)材的(de)最(zui)佳(jia)材(cai)料之一[10]。
铜铟(yin)镓(jia)硒(xi)(简称(cheng)“CIGS”)薄膜太阳电(dian)池(chi)是(shi)一(yi)种最(zui)具有发展前(qian)景的(de)薄膜太(tai)阳(yang)能电(dian)池(chi)��,具(ju)有(you)光电转(zhuan)换效率(lv)高(gao)、无(wu)衰退���、性能(neng)稳(wen)定(ding)、成本(ben)低(di)廉(lian)等诸(zhu)多(duo)优点。在光(guang)伏(fu)领(ling)域(yu)��,国内外(wai)学者们对CIGS 产生(sheng)了极大(da)的关(guan)注���。CIGS 薄膜(mo)太阳(yang)能电池(chi)的(de)第五(wu)层(ceng)就是背(bei)电极��,电(dian)池的(de)性能受背(bei)电(dian)极(ji)材(cai)料(liao)直接(jie)影响(xiang)���。Mo溅(jian)射(she)的薄(bao)膜热(re)稳(wen)定性(xing)良(liang)好(hao)�、电(dian)阻率(lv)较低、还能(neng)与CIGS 层结合(he)形成良好(hao)的(de)欧姆(mu)接触(chu)�����。同时(shi)金(jin)属(shu)Mo 薄膜还具(ju)有(you)与上下(xia)玻璃层和(he)CIGS 近似(shi)的热(re)膨胀(zhang)系数等(deng)特点(dian),已(yi)成为(wei)薄膜太阳(yang)电池背电(dian)极的(de)必选材(cai)料(liao)[11]。图(tu)2 是Mo 在(zai)薄(bao)膜(mo)太(tai)阳(yang)能电池中的位置(zhi)[5]。近(jin)些(xie)年来����,全球(qiu)的(de)太阳(yang)能(neng)电池(chi)需(xu)求(qiu)量激(ji)增��,每年递增40 %以上(shang)��。据(ju)报(bao)道(dao)�����,目前(qian)世界(jie)薄膜(mo)太阳能电池年发电(dian)总(zong)量(liang)约(yue)为(wei)660 MW[10]。国内(nei)研(yan)发Mo 靶的(de)主要(yao)单(dan)位(wei)有金(jin)堆(dui)城(cheng)钼(mu)业、北京(jing)安泰科技���、洛(luo)阳(yang)高新(xin)四(si)丰等。安(an)泰科(ke)技公(gong)司采用(yong)压(ya)制(zhi)-烧结-热等静压(ya)法(fa)制备(bei)的(de)了(le)大量(liang)钼及其合(he)金靶材,相对(dui)密度(du)逸99 %[12]。
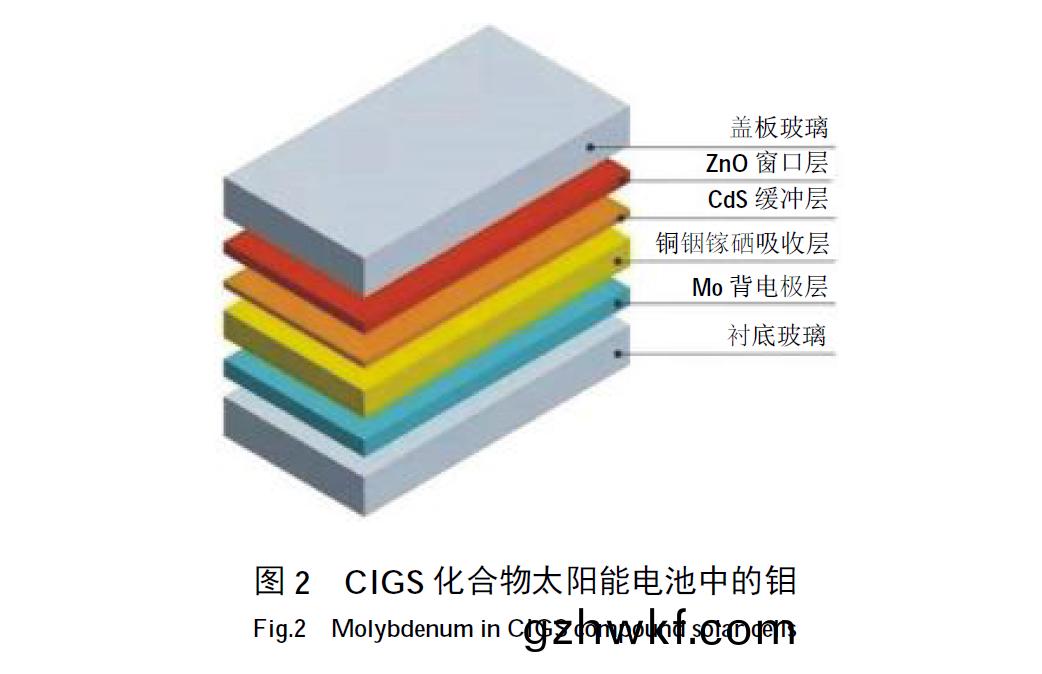
1.3 钽(tan)靶(ba)
当大规模(mo)集(ji)成(cheng)电路(lu)进入到深(shen)亚微米时代时(shi)��,Al线(xian)对应力(li)迁移(yi)和(he)电迁移的抵抗(kang)能(neng)力(li)相对较弱(ruo)��,这(zhe)将造(zao)成(cheng)布线空(kong)洞(dong),导(dao)致(zhi)电(dian)路系(xi)统(tong)完全(quan)失(shi)效(xiao)��。因(yin)此,金属(shu)Cu 布(bu)线将(jiang)成为主流(liu)。Cu 比(bi)Al 具(ju)有更高(gao)的(de)抗(kang)电迁(qian)移能(neng)力(li)和(he)更低(di)的电阻率(lv)��,这(zhe)意(yi)味着更(geng)小�����、更(geng)密集(ji)的连线(xian)可(ke)以(yi)承(cheng)载更强(qiang)的(de)电流(liu)。低(di)电(dian)阻提高(gao)了(le)芯片速(su)度(du)����。目前(qian)全(quan)球(qiu)130 nm�����、90 nm 及以(yi)下(xia)的器件(jian)生(sheng)产(chan)商(shang)已经(jing)采用
Cu 互(hu)连(lian)工(gong)艺����,Ta成为(wei)Cu 互连的(de)阻(zu)挡层。目(mu)前���,超大规(gui)模集成电路(lu)已逐渐(jian)发(fa)展为(wei)Cu/Ta 系(xi)[13-14]�����。因为Cu和Si 的化学活性(xing)高(gao),扩散速度(du)快(kuai)���,易形成铜(tong)硅合(he)金(jin)(Cu-Si)��,铜(tong)在硅(gui)中(zhong)形(xing)成深(shen)的空穴,设备的性(xing)能(neng)被严(yan)重(zhong)影(ying)响,最终(zhong)导(dao)致系(xi)统(tong)失效(xiao)��。Ta 及(ji)Ta的(de)化合(he)物(wu)具有(you)高热(re)稳(wen)定性(xing)��、高导电(dian)性和(he)对外来(lai)原(yuan)子的阻挡作(zuo)用�����。
Cu 和Ta 以及(ji)Cu 和N 之(zhi)间(jian)不(bu)反(fan)应��,不扩(kuo)散形(xing)成(cheng)化(hua)合(he)物(wu),因此Ta 和Ta基膜(mo)成(cheng)为阻(zu)挡层可(ke)有效(xiao)防止(zhi)铜(tong)的扩(kuo)散(san)[15]。
我(wo)国(guo)Ta 储(chu)量资(zi)源丰(feng)富(fu),但在过(guo)去对半(ban)导体溅射靶(ba)材(cai)缺(que)乏最基本(ben)的认识,从而(er)限制了高纯Ta 靶(ba)材(cai)的(de)技(ji)术(shu)发(fa)展(zhan)��。在很长一(yi)段(duan)时(shi)间内����,我国(guo)生产(chan)溅射(she)靶(ba)材(cai)用(yong)的(de)高纯(chun)Ta 原(yuan)料(liao)主(zhu)要(yao)依(yi)赖进口。宁(ning)夏东方(fang)钽(tan)业通(tong)过(guo)多年研发���,掌握(wo)了(le)高纯Ta 溅射(she)靶(ba)材原料(liao)生产(chan)工艺(yi)方法(fa)�����,填(tian)补(bu)了国内(nei)空白���。宁波(bo)江丰电(dian)子材(cai)料股(gu)份有限(xian)公(gong)司也(ye)生(sheng)产(chan)出了(le)300 mm高纯Ta 溅射(she)靶(ba)材[14]�。西(xi)安(an)诺博(bo)尔稀(xi)贵(gui)金(jin)属(shu)公司(si)也(ye)掌握(wo)高纯(chun)Ta 靶(ba)的(de)生产工(gong)艺[16]���。
1.4 铌(ni)靶
近些(xie)年����,光电技(ji)术(shu)的(de)发展迅(xun)速�����,Nb 薄(bao)膜(mo)材(cai)料已(yi)广(guang)泛(fan)应(ying)用于(yu)与(yu)人们(men)现(xian)代(dai)生活密(mi)切(qie)相关的LCD、TFT等离(li)子(zi)显示(shi)屏(ping)�、相机(ji)镜(jing)头(tou)镀(du)膜(mo)、光学(xue)镜(jing)头镀膜��、汽(qi)车(che)和建(jian)筑工(gong)业用玻璃(li)的制(zhi)造(zao)中[17]。铌(ni)靶材(cai)还用(yong)于表(biao)面工(gong)程材(cai)料,如(ru)化工(gong)耐(nai)腐蚀�����、船舶����、耐(nai)热���、电子(zi)成像(xiang)�����、信(xin)息储存����、高(gao)导电(dian)等(deng)镀膜(mo)行(xing)业[18]。由于(yu)高(gao)的利(li)用率,旋转空心(xin)圆(yuan)管磁控(kong)溅射(she)靶目(mu)前在业(ye)内(nei)得到(dao)广(guang)泛(fan)推(tui)广(guang)�����,铌管(guan)靶(ba)主(zhu)要(yao)应(ying)用于平(ping)面显示(shi)器�����、先(xian)进(jin)触控屏(ping)和(he)节能玻璃(li)的(de)表面(mian)镀膜(mo)等行业(ye),对玻(bo)璃(li)屏幕起抗(kang)反(fan)射(she)作用(yong)[19]。
我国(guo)研(yan)发Nb靶(ba)的(de)主要(yao)单(dan)位(wei)有(you)宁(ning)夏东方(fang)钽(tan)业(ye)、西北(bei)有色金属(shu)研究院(yuan)等(deng)��。据笔者了解(jie),宝(bao)鸡(ji)佳(jia)军(jun)公(gong)司通过(guo)熔(rong)炼挤(ji)压(ya)方式生产出了外径152mm�,内(nei)径125mm���,长(zhang)度(du)为3 900 mm 的(de)大(da)2����、靶(ba)材(cai)的技(ji)术(shu)要求(qiu)
为了确(que)保沉积薄(bao)膜的(de)质量(liang)和(he)提(ti)高溅(jian)射效(xiao)率(lv),靶材(cai)的品质(zhi)成为关(guan)键(jian)因素��。经过国内(nei)外(wai)大(da)量研究(jiu)得出,对溅(jian)射靶材(cai)质(zhi)量(liang)影(ying)响(xiang)最大(da)的几个(ge)因素(su)分别(bie)为(wei):纯净(jing)度(du)、致密(mi)度、尺寸精(jing)度(du)、晶(jing)粒度(du)、织(zhi)构等(deng)。
2.1 纯度
溅(jian)射(she)靶材(cai)的(de)纯度(du)是影响(xiang)镀膜效(xiao)果(guo)的(de)首要(yao)因素�����。靶(ba)材(cai)中(zhong)的(de)杂质和气孔中的氧(yang)和(he)水分是(shi)沉积薄膜的(de)主(zhu)要(yao)污染(ran)源(yuan)。要(yao)提高溅射薄(bao)膜(mo)的(de)性能(neng)����,就应尽(jin)可能降低靶材中(zhong)杂(za)质含(han)量�����,提高纯(chun)度,减少污染(ran)源,提高(gao)沉积(ji)薄(bao)膜的(de)均匀(yun)性(xing)[2]�。不(bu)同应(ying)用(yong)领(ling)域的靶材(cai)对纯度(du)要(yao)求不同�����,普(pu)通(tong)镀(du)膜(mo)用靶(ba)材(cai)要求(qiu)纯(chun)度(du)达(da)到(dao)99 %以(yi)上(shang)即能满足(zu)要(yao)求。对靶材纯度要求(qiu)较为(wei)苛刻的(de)是(shi)微电子(zi)、显(xian)
示器等领(ling)域用(yong)�,需要至少分析40 个以(yi)上(shang)的(de)杂质元(yuan)素,纯度(du)为99.95 %(3N5)以上(shang)方可(ke)使(shi)用(yong)[20]。
2.2 致(zhi)密度
溅射(she)靶材的内(nei)部(bu)如(ru)不(bu)是(shi)非(fei)常致密���,或存积(ji)气体,那么(me)在溅(jian)射(she)过程中气体(ti)释(shi)放将(jiang)会产生微(wei)粒直(zhi)接影响(xiang)镀膜(mo)质量(liang)。气(qi)孔同(tong)时(shi)会导致(zhi)溅射(she)时产生(sheng)不正(zheng)常放电(dian)���,而产生杂质(zhi)粒子(zi)���。为(wei)了保(bao)证(zheng)薄(bao)膜(mo)的质量(liang)和(he)性(xing)能��,必(bi)须使(shi)溅射(she)靶(ba)材(cai)的(de)致密度(du)要达(da)到(dao)较(jiao)高(gao)水平。靶(ba)材致密(mi)度(du)越高(gao)���,其(qi)导(dao)电(dian)、导热(re)性(xing)越好�,强(qiang)度(du)越高等。高致密度靶(ba)材镀膜有诸(zhu)多优点:靶材(cai)使(shi)用(yong)寿命(ming)长��,溅射功率小,成膜速(su)率(lv)高(gao)��,薄(bao)膜不易(yi)开裂,透(tou)光率(lv)高(gao)。
2.3 微观(guan)组(zu)织
溅射速(su)度(du)直(zhi)接受(shou)晶(jing)粒(li)尺寸(cun)的影响(xiang)��,晶(jing)粒粗大靶(ba)材的(de)溅(jian)射速(su)率要比晶粒细小的(de)靶材慢(man)很多���,晶(jing)粒尺(chi)寸(cun)变(bian)小(xiao)��,薄膜(mo)沉积速(su)率增大(da)��。而同(tong)一(yi)块(kuai)靶材(cai)的(de)晶粒尺寸整体(ti)差异较小(xiao),沉积薄膜(mo)的(de)厚度分布就更为均(jun)匀(yun)�。金堆城(cheng)钼业研发的钼(mu)靶(ba)材平均晶粒尺寸达(da)到(dao)50 滋m,属(shu)国(guo)内领(ling)先(xian)水平(ping)[21]。一(yi)般(ban)情况(kuang)下(xia),因(yin)为变形量(liang)等(deng)因素影(ying)响(xiang),平(ping)面(mian)靶的晶(jing)粒(li)尺(chi)寸(cun)比管(guan)状(zhuang)靶(ba)材更容(rong)易(yi)细小�、均(jun)匀。
当(dang)靶材在(zai)溅(jian)射(she)时,其原(yuan)子(zi)会沿着六方(fang)密排面(mian)优(you)先溅(jian)射出(chu)来,因(yin)此�����,为(wei)了(le)提(ti)高溅(jian)射镀(du)膜速率(lv),可(ke)以尽可(ke)能(neng)调整靶材结(jie)构使具有一定(ding)的(de)晶(jing)体(ti)取(qu)向(xiang)����。在晶粒(li)尺寸合适(shi)的范(fan)围内(nei)�,晶粒取(qu)向(xiang)越(yue)均匀越(yue)好�。靶(ba)材(cai)晶(jing)粒(li)取向(xiang)还会对薄(bao)膜(mo)的(de)厚(hou)度(du)、均匀性(xing)都(dou)会产(chan)生(sheng)较大(da)影响(xiang)����。
要使(shi)靶材的微(wei)观组(zu)织具(ju)有(you)一(yi)定(ding)的结(jie)晶取向(xiang),就(jiu)要(yao)根(gen)据(ju)靶材(cai)金(jin)属的(de)微观(guan)组(zu)织(zhi)特(te)征���,采(cai)用(yong)不同(tong)的(de)压力加(jia)工(gong)方(fang)式(shi)�,再(zai)结合适(shi)当的热处理(li)进(jin)行(xing)调整(zheng)和控制�。国内(nei)许多单位已(yi)对(dui)不同(tong)加(jia)工方(fang)式对(dui)结晶(jing)取向的影(ying)响做(zuo)了大量研(yan)究。
2.4 尺寸精(jing)度
溅射靶(ba)材在(zai)后期(qi)装(zhuang)配前要(yao)进(jin)行一系列机(ji)械(xie)加工(gong),其加工(gong)质(zhi)量和(he)精度(du)(平面(mian)度,直线度(du),粗糙(cao)度(du))也会(hui)影(ying)响(xiang)到(dao)薄膜性能(neng)����。靶材溅射作(zuo)业(ye)前(qian)必(bi)须(xu)与(yu)铝(lv)或(huo)无氧铜(tong)底盘(pan)(背(bei)板)连(lian)接在(zai)一(yi)起(qi)����,配合紧密才能(neng)使(shi)靶(ba)材(cai)与背板(ban)更好(hao)的(de)导(dao)电(dian)导热(re)。装(zhuang)配完(wan)毕(bi)后(hou)要(yao)使用(yong)超声波检测,如(ru)果(guo)两者的(de)空(kong)隙(xi)区域(yu)小(xiao)于总接(jie)触面的(de)2 %����,这样(yang)才能(neng)在(zai)大功率(lv)溅(jian)射中(zhong)使(shi)用(yong)[10]���。同样的尺(chi)寸精度要(yao)求(qiu)下(xia),管(guan)状(zhuang)靶材的机加(jia)工难(nan)度要(yao)大于平(ping)面靶材��,因(yin)为(wei)大(da)型管靶(ba)一(yi)般都(dou)采用(yong)挤压(ya)成型(xing)��,内(nei)孔(kong)有(you)较(jiao)深(shen)的挤(ji)压(ya)沟槽��,这(zhe)对机加造成(cheng)了(le)较(jiao)大(da)困难(nan)。业(ye)内(nei)一般(ban)采(cai)用(yong)高精度(du)数控(kong)深(shen)孔钻(zuan)镗(tang)床(chuang)来(lai)加工(gong)内孔����。
3�、难(nan)熔(rong)金属靶(ba)材(cai)的(de)制(zhi)备技术(shu)
难熔(rong)金属(shu)溅(jian)射靶材(cai)的(de)制备方(fang)法主要分(fen)为粉末冶(ye)金法(fa)和(he)熔(rong)炼法(fa)�,其(qi)中W�����、Mo多采(cai)用粉末冶(ye)金(jin)��,而(er)Ta、Nb 多(duo)采用熔炼法生(sheng)产(chan),具体工艺流程(cheng)见图3。

3.1 粉末(mo)冶金法
粉末冶金法(fa)是(shi)适合制作(zuo)难熔(rong)金属(shu)溅(jian)射(she)靶材的传(chuan)统方法���。难熔金(jin)属(shu)熔(rong)点(dian)很高(gao),该(gai)方法采用(yong)固 液(ye)相烧(shao)结(jie)�����,所(suo)以(yi)在远(yuan)低(di)于(yu)其熔点(dian)的(de)温(wen)度(du)下使(shi)其成型;生产合金靶材时(shi)��,两种(zhong)或(huo)两种(zhong)以上的合(he)金(jin)粉末通过(guo)混料(liao)机长(zhang)时间混(hun)合(he)均匀(yun)后(hou)加热(re)压(ya)制(zhi),有效(xiao)地(di)杜(du)绝了(le)合金(jin)组(zu)元(yuan)的偏析。另外(wai)一(yi)大优点是(shi)粉(fen)末(mo)冶(ye)金法制(zhi)备的(de)靶材晶粒较(jiao)细(xi)���,可达到100 滋m以下(xia)��。一(yi)般(ban)粉(fen)末冶(ye)金(jin)法(fa)制(zhi)
备(bei)的(de)溅射(she)靶(ba)材(cai)多(duo)采(cai)用冷等(deng)静(jing)压(ya)加烧(shao)结(jie)�����、热(re)压烧结(jie)和(he)热等静(jing)压三种(zhong)方(fang)式�。其(qi)中(zhong)热等静(jing)压得到(dao)的致密度最(zui)高,前(qian)两(liang)种方法得(de)到的(de)靶材(cai)致密度则相(xiang)对(dui)较(jiao)低����。因此(ci)提(ti)高(gao)粉末(mo)冶金(jin)烧(shao)结(jie)法(fa)制备靶材致(zhi)密(mi)度(du)是(shi)必(bi)须(xu)解决的关键(jian)技(ji)术(shu)之一����。通过压力加工(gong)可有效改善粉(fen)末(mo)冶金靶材的致密度低的(de)问题(ti)。魏修(xiu)宇(yu)[7]研究(jiu)了轧制变(bian)形量对粉末(mo)冶金钨靶材(cai)致密(mi)度的影(ying)响(xiang)�,随(sui)着变(bian)形(xing)增(zeng)
大,致(zhi)密(mi)度(du)增(zeng)加(jia),最(zui)高可(ke)达99.5 %以上。朱琦[22]研(yan)究(jiu)了挤压(ya)对粉(fen)末冶金钼(mu)管(guan)靶组(zu)织�����、性能以及致(zhi)密(mi)度(du)的影(ying)响,使(shi)钼(mu)管靶密度从(cong)烧结坯(pi)的(de)9.8 g/cm3 增加(jia)到10.15 g/cm3�,达(da)到(dao)了高致(zhi)密(mi)度(du)的要(yao)求���。
钨�����、钼溅射(she)靶材大(da)多(duo)采(cai)用粉末(mo)冶金(jin)方法(fa)制备,由于粉(fen)末冶(ye)金(jin)的提(ti)纯(chun)能(neng)力有(you)限(xian)�,因(yin)此(ci)原(yuan)料必须(xu)为(wei)高纯粉(fen)末(mo),另外在制(zhi)备过程(cheng)还(hai)要严格控(kong)制杂质(zhi)元(yuan)素的(de)混(hun)入。目前国内高纯金(jin)属(shu)的(de)提(ti)纯技(ji)术与工业(ye)发(fa)达国家(jia)的差距较大(da)。郭让(rang)民(min)[23]将仲(zhong)钨(wu)酸(suan)铵重新(xin)氨(an)溶(rong)中(zhong)和,活(huo)性(xing)炭(tan)吸附(fu)结(jie)晶提纯(chun),再(zai)经还(hai)原后(hou)制备(bei)出(chu)高(gao)纯(chun)W粉(fen),可(ke)有效地(di)深度去(qu)除杂(za)质�����,纯度(du)达(da)99.99%以(yi)上。
3.2 熔(rong)炼法(fa)
熔(rong)炼(lian)法(fa)是(shi)制备难熔金属(shu)靶材(cai)另一种重(zhong)要(yao)的(de)方法,因(yin)为难熔金(jin)属(shu)的(de)具有(you)高熔(rong)点��,多采用(yong)电子(zi)束(shu)、电(dian)弧熔(rong)炼��。电(dian)子(zi)束熔(rong)炼(lian)具(ju)有高(gao)温、高(gao)升(sheng)温(wen)速(su)率(lv)�、高真(zhen)空等(deng)优点��,适(shi)合提纯精炼各种难(nan)熔(rong)金(jin)属(shu)��。电子束熔炼(lian)得到(dao)的金属(shu)铸(zhu)锭致密����,内部(bu)组(zu)织(zhi)无孔(kong)隙(xi)、气(qi)孔�,非(fei)常(chang)接(jie)近(jin)理(li)论(lun)密(mi)度(du)。但电子束熔(rong)炼有(you)两(liang)大(da)缺点:一是铸(zhu)锭(ding)晶(jing)粒粗(cu)大(da);二(er)是(shi)熔(rong)炼合(he)金(jin)时(shi)对(dui)于(yu)组(zu)元蒸(zheng)气压(ya)相(xiang)差(cha)较大
情况下,会发生偏(pian)析(xi)现象。电弧熔(rong)炼适(shi)合熔炼合金(jin),其(qi)铸(zhu)锭致密(mi)度(du)也非(fei)常高(gao),但提(ti)纯(chun)效果不及(ji)电(dian)子(zi)束(shu)熔(rong)炼���。由(you)于熔(rong)炼(lian)法得(de)到(dao)的(de)靶材(cai)晶(jing)粒(li)粗大(da),通过压力(li)加(jia)工和热(re)处理(li)可使(shi)晶粒(li)变(bian)细,并(bing)得到一(yi)定(ding)晶粒取向的(de)组(zu)织(zhi)���。刘(liu)宁[14]研(yan)究了(le)钽(tan)靶中(zhong){110}、{100} ����、{111}三(san)种织(zhi)构的溅(jian)射速(su)率关系,提(ti)出(chu)采用(yong)热锻(duan)造强塑性变(bian)形(xing)工(gong)艺(yi)对(dui)Ta 靶(ba)进行(xing)加(jia)工,使其(qi)具有更均(jun)匀(yun)的织(zhi)构组分����。
宜楠(nan)[13]通(tong)过对(dui)电子(zi)束(shu)熔(rong)炼、锻造、轧制、热(re)处理(li)等关键(jian)工艺(yi)进(jin)行(xing)优化(hua)调整,获(huo)得(de)了织(zhi)构(gou)以(yi){111}型为(wei)主晶(jing)粒(li)尺寸(cun)小(xiao)于100 滋(zi)m性(xing)能(neng)优(you)良的钽靶(ba)����。王(wang)国栋[17]研(yan)究(jiu)了(le)电(dian)子束(shu)熔(rong)炼(lian)的(de)高(gao)纯(chun)铌(ni)锭(ding)在加热(re)1 100 益(yi)高(gao)温镦造(zao)再通过换向轧制(zhi)制(zhi)备的Nb 靶(ba)材���,其(qi)晶(jing)粒取向(xiang)一致(zhi),晶粒(li)大小分布(bu)均(jun)匀(yun)�。笔(bi)者对纯Nb 板靶材(cai)也进行(xing)了一(yi)系(xi)列试(shi)验。电子束熔(rong)炼(lian)的粗大(da)晶(jing)粒(li)纯(chun)Nb 铸锭通过(guo)锻(duan)造、退火�����、再(zai)经60 %变形量(liang)的(de)轧(ya)制�,再进行(xing)约(yue)1 200 益左(zuo)右(you)的成品退(tui)火(huo)得到7.5 级(ji)晶粒(li)度(平(ping)均晶(jing)粒(li)数(shu)为1 400 个(ge)/mm2)�,组织均匀、性(xing)能(neng)优良(liang)的纯Nb靶(ba)材(cai)��。
4 �、结语(yu)
近些年来(lai)�,我(wo)国(guo)研究生(sheng)产溅(jian)射靶(ba)材的单(dan)位企(qi)业(ye)在(zai)制(zhi)备技术(shu)、产(chan)品品(pin)种等方面(mian)都有(you)非常大(da)的进步。打(da)破(po)了(le)高端靶材长期(qi)依(yi)赖进口(kou)的(de)局面(mian)。研发(fa)生(sheng)产(chan)靶材的(de)中小(xiao)型民(min)营(ying)企业(ye)也取(qu)得了(le)很大成(cheng)果。薄(bao)膜(mo)市(shi)场(chang)需求的快(kuai)速(su)发(fa)展�����,溅射(she)靶材品(pin)种要求(qiu)也越来(lai)越多,加(jia)速了(le)更(geng)新换代周期,传(chuan)统工(gong)艺(yi)也慢(man)慢(man)不能(neng)满(man)足(zu)要求�����,需要对(dui)工艺进行优化(hua)和革新(xin)�。今(jin)后(hou)的(de)发展方向是(shi)要(yao)引(yin)
入新(xin)方(fang)法新(xin)工(gong)艺(yi)来解决(jue)靶(ba)材在(zai)溅(jian)射过(guo)程(cheng)中(zhong)微(wei)粒(li)飞(fei)溅���、利用率(lv)和(he)导磁率(lv)等问题���。靶(ba)材(cai)的目的(de)是(shi)溅镀薄膜�,只研究靶(ba)材远远不够(gou),需要将靶材(cai)与(yu)薄膜(mo)两种(zhong)研(yan)究(jiu)结(jie)合起来(lai),努力促进(jin)靶(ba)材(cai)制备(bei)技术的(de)革新(xin)与(yu)发展。
参(can)考文献:
[1] 陈(chen)海(hai)峰(feng)�����,薛(xue)莹(ying)洁(jie).国内外(wai)磁控(kong)溅射(she)靶材的(de)研(yan)究进(jin)展[J].表(biao)面(mian)技(ji)术,2016���,45(10):56-63.
CHEN Haifeng�����,XUE Yingjie. Research progress of magnetronsputtering target at home and abroad [J]. Surface Technology,2016,45(10):56-63.
[2] 刘(liu)志坚(jian)����,陈远(yuan)星(xing),黄伟嘉�,等. 溅射(she)靶(ba)材的应(ying)用(yong)及(ji)制(zhi)备(bei)初探[J].南(nan)方金(jin)属�����,2003(6):23-24.
LIU Zhijian���,CHEN Yuanxing����,HUANG Weijia,et al.Manufactureand application of sputtering target materials [J].Southern Metals����,2003(6):23-24.
[3] 金(jin)永(yong)中,刘东亮��,陈(chen)建(jian).溅(jian)射(she)靶(ba)材的(de)制备(bei)及(ji)应(ying)用(yong)研(yan)究[J].四川(chuan)理工学(xue)院(yuan)学(xue)报(自然科学版(ban)),2005�����,18(3):22-24.
JINYongzhong�����,LIUDongliang,CHENJian.Studying on manufactureand application of sputtering target materials [J].Journal of SichuanUniversity of Science & Engineering (Natural Science Edition),2005,18(3):22-24.
[4] 储志强.国(guo)内(nei)外磁(ci)控溅射靶(ba)材的现(xian)状及(ji)发(fa)展(zhan)趋势(shi)[J].金(jin)属材料与(yu)冶(ye)金工(gong)程�����,2011(4):44-49.
CHU Zhiqiang. The present status and development trend of mag netron sputtering target at home and abroad[J]. Metal Materials and Metallurgy Engineering���,2011(4):44-49.
[5] 殷为(wei)宏(hong),汤(tang)慧(hui)萍.难(nan)熔(rong)金(jin)属材料与(yu)工(gong)程应(ying)用[M].北(bei)京:冶(ye)金(jin)工业出版(ban)社,2012:253.
[6] 王大勇(yong),顾(gu)小(xiao)龙(long).靶材(cai)制备研究现(xian)状及(ji)研发(fa)趋势[J].浙(zhe)江(jiang)冶(ye)金,2007(4):1-9.
WANG Dayong���,GU Xiaolong. Research Status and DevelopmentTrend of Target Preparation [J]. Journal of Zhejiang Metallurgy,2007(4):1-9.
[7] 魏修宇(yu).半导(dao)体(ti)用高纯(chun)钨靶材(cai)的制(zhi)备(bei)技(ji)术(shu)与(yu)应(ying)用(yong)[J].硬(ying)质(zhi)合(he)金,2017���,34(5):353-359.
WEI Xiuyu.Preparation technology and application of high puritytungsten target for semiconductor [J].Cemented Carbide�,2017���,34(5):353-359.
[8] 尚再艳�,江轩(xuan)��,李勇军,等(deng).集成电路(lu)制造(zao)用溅射(she)靶材(cai)[J].稀有金属(shu),2016,29(4):475-477.
SHANG Zaiyan,JIANG Xuan��,LI Yongjun,et al. Sputtering targetsused in integrated circuit [J]. Chinese Journal of Rare Metals�����,2016,29(4):475-477.
[9] 迟(chi)伟光��,张凤(feng)戈�����,王铁(tie)军,等(deng).溅(jian)射靶(ba)材的应用及发展前景(jing)[J].新材(cai)料(liao)产(chan)业,2010(11):6-11.
CHI Weiguang�,ZHANG Fengge��,WANG Tiejun,et al.Applicationanddevelopmentprospectofsputteringtargets[J].AdvancedMaterialsIndustry,2010(11):6-11.
[10] 安耿,李(li)晶(jing)���,刘仁智(zhi)����,等.钼(mu)溅射靶材(cai)的(de)应(ying)用、制备及(ji)发(fa)展[J].中国(guo)钼业(ye),2011,35(2):45-48.
AN Geng,LI Jing�,LIU Renzhi,et al. The application�,manufacture原anddeveloping trend ofmolybdenum sputtering target [J]. ChinaMolybdenumIndustry,2011�����,35(2):45-48.
[11] 沈(shen)晓月. 磁(ci)控溅射法制(zhi)备CIGS 薄膜光伏(fu)电(dian)池Mo 背电(dian)极(ji)的研(yan)究(jiu)[D].大连:大连(lian)工业(ye)大学,2013.
SHEN Xiaoyue. Study on Mo back electrode of CIGS thin filmphotovoltaic cells prepared by magnetron sputtering [D]. Dalian:Dalian Polytechnic University����,2013.
[12] 安(an)泰科(ke)技股(gu)份有(you)限公司(si).高(gao)纯度���、高致密度、大(da)尺寸钼合(he)金靶材(cai)的(de)制(zhi)备方法:CN105525260A[P]. 2013-09-25.
[13] 宜楠(nan)����,权(quan)振(zhen)兴����,赵(zhao)鸿磊,等(deng).集(ji)成(cheng)电路(lu)用钽(tan)溅射靶材(cai)制备工(gong)艺研究[J].材(cai)料开发(fa)与应用,2016,31(3):71-75.
YI Nan,QUAN Zhenxing,ZHAO Honglei,et al. Research onprocessing of tantalum target for sputtering to LSIS[J]. Developmentand Application of Materials,2016,31(3):71-75.
[14] 刘宁���,杨(yang)辉,姚(yao)力军���,等(deng).集成(cheng)电路(lu)用大(da)尺(chi)寸(cun)高纯钽靶(ba)材的制(zhi)备(bei)工艺(yi)进展(zhan)[J].集(ji)成(cheng)电(dian)路(lu)应用,2018��,35(2):24-28.
LIU Ning��,YANG Hui���,YAO Lijun��,et al.The progresses onfabrication of large size high-purity tantalum targets for integratedcircuits[J]. Applications of IC,2018,35(2):24-28.
[15] 潘伦桃(tao)����,李彬(bin),郑爱国�����,等(deng).钽在集成电路(lu)中的应用[J].稀(xi)有(you)金(jin)属(shu),2003���,27(1):28-34.
PAN Luntao����,LI Bin,ZHENG Aiguo,et al. Application of tantalumto LSIC[J].Chinese Journal of Rare Metals,2003,27(1):28-34.
[16] 郝小(xiao)雷. 组织(zhi)均匀(yun)钽溅(jian)射(she)靶(ba)材(cai)的(de)制备(bei)现(xian)状(zhuang)[J]. 山东(dong)工业技(ji)术(shu)�,2017(18):63-63.
HAO Xiaolei. Preparation status of tissue homogeneous tantalumsputtering targets [J].Shandong Industrial Technology�����,2017(18):63-63.
[17] 王(wang)国栋,王艳(yan)�,李高林(lin),等(deng).溅(jian)射用(yong)优(you)质铌(ni)靶(ba)材的制(zhi)备[J].稀(xi)有(you)金属材料与工程(cheng),2008(4):533-536.
WANGGuodong�����,WANGYan�����,LIGaolin,etal.Processingofniobiumtarget for sputting [J]. Rare Metal Materials and Engineering,2008(4):533-536.
[18] 李兆(zhao)博,张(zhang)春恒(heng)�����,李桂(gui)鹏,等(deng).溅(jian)射镀膜(mo)用铌靶材晶粒尺(chi)寸控(kong)制(zhi)工(gong)艺(yi)研究[J]. 材料开(kai)发(fa)与(yu)应用(yong)�����,2010,25(6):33-35.
LI Zhaobo,ZHANG Chunheng�,LI Guipeng,et al. Research ongrain size controlling process of niobium target used for sputteringand coating[J]. Development and Application of Materials,2010�,25(6):33-35.
[19] 张国军����,汪(wang)凯�����,李桂(gui)鹏,等.旋(xuan)转镀膜(mo)铌(ni)靶(ba)材(cai)加工工(gong)艺研究(jiu)[J].材(cai)料开发(fa)与(yu)应用���,2014���,29(6):54-57.
ZHANG GuoJun,WANG Kai�,LI Guipeng,et al. Processing technology of spin coating process niobium target [J]. Development andApplication of Materials,2014,29(6):54-57.
[20] 贾国斌(bin),冯(feng)寅(yin)楠���,贾(jia)英.磁(ci)控溅射(she)用(yong)难熔金(jin)属(shu)靶材(cai)制(zhi)作���、应(ying)用与(yu)发展[J].金属功能材料,2016�,23(6):48-52.
JIA Guobin,FENG Yinnan,JIA Ying.Manufacture,application anddevelopment of refractory metal target used on magnetron sputtering[J]. Metallic Functional Materials,2016,23(6):48-52.
[21] 杨(yang)帆(fan),王(wang)快(kuai)社(she),胡(hu)平(ping)����,等(deng).高纯钼溅(jian)射靶材的研(yan)究(jiu)现(xian)状(zhuang)及发展趋势(shi)[J].热(re)加(jia)工工艺,2013(24):10-12.
YANG Fan��,WANG Kuaishe,HU Ping,et al. Research status anddevelopment trend of high purity molybdenum sputtering targetmaterial[J]. Hot Working Technology�,2013(24):10-12.
[22] 朱(zhu)琦(qi)���,王林�����,杨(yang)秦莉(li),等.钼(mu)管靶材的(de)挤(ji)压(ya)理论(lun)与(yu)组织(zhi)性(xing)能(neng)分(fen)析[J].中(zhong)国钼(mu)业���,2014(4):50-53.
ZHU Qi���,WANG Lin���,YANG Qinli,et al. Extrusion theory andanalysis on microstructure and properties of molybdenum tubetarget[J]. China MolybdenumIndustry,2014(4):50-53.
[23] 郭让民(min).高纯钨(wu)溅(jian)射(she)靶材(cai)制(zhi)取(qu)工艺(yi)研究(jiu)[J].中国钼业(ye)��,1997(增(zeng)刊(kan)1):39-41.
GUORangmin. Study on preparation of high pure tungsten materials[J]. China MolybdenumIndustry�����,1997(supply1):39-41.
相(xiang)关(guan)链接(jie)