集(ji)成电(dian)路(lu)产业作为电(dian)子信息(xi)产业的核(he)心(xin)�����,是关系国民经(jing)济和(he)社(she)会发展(zhan)的(de)��,具(ju)有基(ji)础性���、先导(dao)性(xing)和战略(lve)性的产(chan)业�,是衡(heng)量(liang)国(guo)家科技水(shui)平(ping)和(he)创新能(neng)力的重要标(biao)志(zhi)���,受到(dao)众多(duo)国(guo)家(jia)的高(gao)度重(zhong)视(shi),也是发达国(guo)家(jia)实(shi)施技(ji)术封锁的重(zhong)点���。集(ji)成电路微细化制(zhi)程(cheng)技(ji)术(shu)日(ri)新(xin)月(yue)异,结(jie)构尺寸(cun)从微米推(tui)向(xiang)深亚微(wei)米,进而迈入纳米时代。目前国(guo)际(ji)主流(liu)技(ji)术已从14nm技(ji)术向10nm、7nm、5nm甚至(zhi)3nm逐(zhu)步递(di)进,代表公司(si)有台(tai)积电、三(san)星�、英特尔等(deng)。中(zhong)国(guo)目前生(sheng)产线较(jiao)为(wei)成熟(shu)的技(ji)术(shu)是(shi)45nm和28nm����,领先技(ji)术(shu)达(da)到14nm。随着(zhe)集成电(dian)路线(xian)宽(kuan)世代(dai)的发(fa)展(zhan)�����,对用于沉积芯(xin)片(pian)互(hu)连线的(de)靶材(cai)也提出(chu)了更(geng)高(gao)的(de)要求���。
先进(jin)制程集成(cheng)电路制(zhi)备(bei)工艺中广泛(fan)采(cai)用Ta/TaN扩散阻(zu)挡(dang)层与Cu互(hu)连线搭(da)配使(shi)用��,随(sui)着芯(xin)片的集(ji)成(cheng)度与日俱增(zeng)��,特别是技(ji)术节(jie)点(dian)发展(zhan)至(zhi)7nm及以下����,Ta/TaN阻挡(dang)层(ceng)的(de)厚度必须(xu)足(zu)够(gou)薄以(yi)实(shi)现(xian)高集(ji)成(cheng)度芯片的功(gong)能性,这对钽(tan)靶(ba)材(cai)的(de)各项性能,尤(you)其是(shi)晶向(xiang)均(jun)匀性提出(chu)了(le)极(ji)高的(de)要求。钽的(de)晶向会明显影(ying)响(xiang)溅(jian)射速(su)率(lv)����,最(zui)终影响(xiang)沉积(ji)薄(bao)膜(mo)厚(hou)度的(de)均匀性(xing)[1],研(yan)究发现(xian),钽各(ge)织构面溅(jian)射(she)速(su)率(lv)关(guan)系为(wei){110}>{100}>{111}。目前行(xing)业中(zhong)主流(liu)使用的(de)是(shi)轧(ya)制钽靶(ba)材(cai),实际溅(jian)射(she)使(shi)用过程中会(hui)遇(yu)到(dao)大量(liang)的因(yin)晶(jing)向(xiang)不匹(pi)配(pei)产生的问题�。粉末冶(ye)金技(ji)术(shu)广泛(fan)应用于(yu)陶(tao)瓷(ci)靶材的(de)制(zhi)备(bei)��,用(yong)于(yu)制备(bei)钽靶(ba)材(cai)的(de)仅国(guo)外少数(shu)几(ji)家(jia)公司(si),其(qi)在某些方面(mian)的优越性(xing)可能会成(cheng)为(wei)14nm及以(yi)下(xia)技术节点(dian)集(ji)成(cheng)电(dian)路(lu)用钽靶材(cai)的主要(yao)制备(bei)技(ji)术(shu)���。文(wen)章研(yan)究对(dui)比(bi)了轧(ya)制(zhi)钽(tan)靶(ba)材与(yu)粉末(mo)冶金钽靶材的(de)晶向和晶粒(li)���,为(wei)先进(jin)制程(cheng)用(yong)钽(tan)靶材(cai)的(de)开发(fa)提(ti)供一(yi)些参考。
1、实验(yan)材料和方法
轧制钽(tan)靶(ba)材(cai)实(shi)验原(yuan)料(liao)采用(yong)纯(chun)度(du)为(wei)99.95%以上(shang)的高(gao)纯钽粉(fen)末����。高(gao)纯钽粉末经(jing)300MPa冷(leng)等(deng)静(jing)压(ya)后形(xing)成(cheng)具(ju)有一定致密度(du)的坯料(liao)��,坯(pi)料通过(guo)电(dian)子(zi)束熔(rong)炼制(zhi)成(cheng)铸锭,将(jiang)铸(zhu)锭(ding)头(tou)尾(wei)两端缺(que)陷(xian)部(bu)分切除后进行锻(duan)打和轧(ya)制,得(de)到最终样(yang)品尺(chi)寸φ500mm×8mm�����。轧制(zhi)钽靶材(cai)的工(gong)艺流程如图1所(suo)示(shi)。

粉末(mo)冶(ye)金钽靶(ba)材实验原(yuan)料采(cai)用(yong)与轧(ya)制钽靶材相(xiang)同(tong)的纯度为(wei)99.95%以(yi)上的高(gao)纯钽粉(fen)末。高(gao)纯(chun)钽粉末(mo)经300MPa冷(leng)等(deng)静压形(xing)成基(ji)本(ben)的圆(yuan)形坯料(liao)���,将坯(pi)料用不(bu)锈钢包套密封(feng)后(hou)置(zhi)于(yu)热等(deng)静压(ya)设备中(zhong)烧结��,环(huan)境(jing)压(ya)力(li)200MPa�����,温(wen)度1300℃�����,最(zui)终(zhong)得(de)到尺寸同(tong)样(yang)为(wei)φ500mm×8mm,致密度大于(yu)99%的样品(pin)。粉(fen)末(mo)冶(ye)金钽(tan)靶材的工艺(yi)流程(cheng)如图2所(suo)示(shi)。
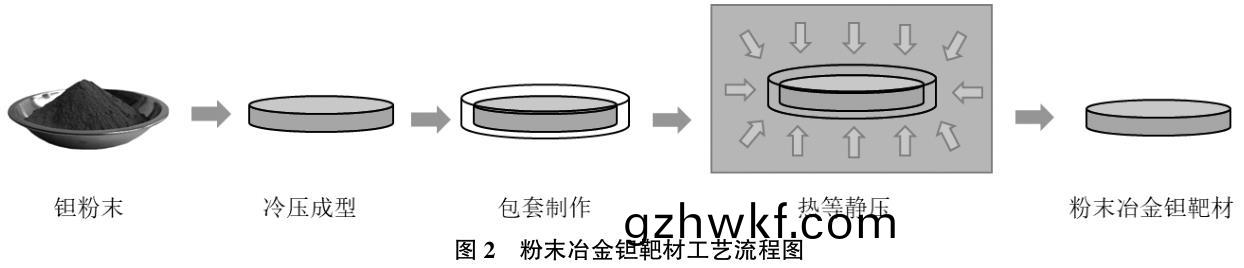
每(mei)个(ge)靶材(cai)按照(zhao)图3所示位(wei)置(zhi)各(ge)取2个分析样�,分析(xi)样品的尺(chi)寸为5mm×5mm×t(厚(hou)度约(yue)8mm)���。将(jiang)分析样品(pin)的检测面研磨(mo)至没有明显划(hua)痕(hen)�����,用(yong)H2SO4∶HNO3∶HF=3∶2∶2(体(ti)积比)的腐蚀(shi)液腐蚀(shi)检(jian)测(ce)面(mian)约30s,腐(fu)蚀(shi)完(wan)成后(hou)用(yong)水(shui)将表面冲洗(xi)干净(jing)��。采用日(ri)立(li)SU3500扫(sao)描(miao)电(dian)子显(xian)微(wei)镜(SEM)搭载牛津(jin)NordlysMax3电子(zi)背散(san)射(she)衍射仪(EBSD)测试(shi)靶(ba)材断面的(de)晶(jing)向(xiang)�����。其(qi)基(ji)本原理是利(li)用满(man)足布(bu)拉(la)格(ge)衍(yan)射(she)条件(2dsinθ=nλ)的背散射(she)电子(zi)得到(dao)一系列菊(ju)池花(hua)样,根据(ju)菊(ju)池(chi)花(hua)样(yang)的特(te)点(dian)得(de)出晶(jing)面间距和晶(jing)面(mian)之间(jian)的(de)夹(jia)角,然后(hou)从(cong)数据库中查找(zhao)相关(guan)的(de)晶体结(jie)构和(he)晶胞参(can)数,最(zui)终以(yi)不同方向(xiang)占(zhan)比以及极(ji)图(tu)强度(du)来(lai)表(biao)征织构[2-3]。另外采用OlympusPME3型(xing)倒置(zhi)式金相显微(wei)镜观(guan)察(cha)微观晶(jing)粒,依(yi)据(ju)标(biao)准GB/T6394—2002,使用直(zhi)线(xian)截点(dian)法(fa)计(ji)算(suan)平(ping)均(jun)晶(jing)粒(li)度����。
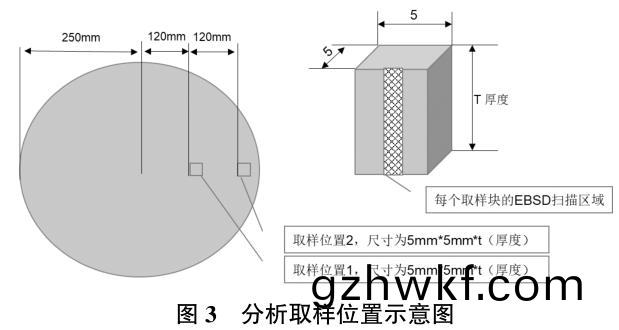
2�����、实验结(jie)果(guo)和分析(xi)
样(yang)品EBSD分析(xi)结(jie)果如图(tu)4所示,不(bu)同颜(yan)色代表(biao)不(bu)同(tong)晶(jing)面(mian)取(qu)向(xiang),对(dui)于具(ju)有体(ti)心立方结(jie)构的钽材料主要(yao)比较(jiao){100}���、{110}�����、{111}三(san)种(zhong)晶面(mian)的占(zhan)比(bi)����。从分(fen)析(xi)结(jie)果(guo)图(tu)中(zhong)可以看到(dao),轧制钽的整(zheng)个(ge)断(duan)面(mian)晶(jing)向分(fen)布(bu)不均匀(yun),取样(yang)位置(zhi)1和取样(yang)位置2都存(cun)在(zai)二(er)分(fen)之一厚度(du)附近(jin){111}偏(pian)多的现(xian)象(xiang)。而(er)粉(fen)末(mo)冶金(jin)钽(tan)靶材(cai)的(de)晶向则相(xiang)对(dui)比较均匀,取(qu)样(yang)位(wei)置1和取(qu)样(yang)位(wei)置(zhi)2各(ge)晶面占(zhan)比没(mei)有(you)明显(xian)差异。

统(tong)计4个(ge)分析样品的(de)晶(jing)向占比(bi),结果(guo)如(ru)表(biao)1所示。

从(cong)表(biao)1的数据可(ke)以(yi)发(fa)现(xian),轧(ya)制钽(tan)三种晶(jing)向(xiang)占(zhan)比(bi)相差较(jiao)大����,轧(ya)制钽靶材(cai)位(wei)置1的{111}占(zhan)比最(zui)大为36.7%,{110}占(zhan)比最(zui)小(xiao)仅4.72%����,两者相(xiang)差(cha)31.98%����;轧(ya)制钽靶材位(wei)置2的{100}和(he){111}占比均(jun)为(wei)26.20%,远(yuan)大(da)于(yu){110}仅3.80%的占(zhan)比(bi),差值(zhi)22.40%�����。而(er)粉(fen)末(mo)冶金钽(tan)三种晶(jing)向占比(bi)差(cha)距(ju)较(jiao)小(xiao)�����,粉末冶(ye)金钽(tan)靶材位置1的(de){110}占比最大为20.3%,{100}占比(bi)最(zui)小(xiao)为(wei)9.40%�����,相(xiang)差不足11%;粉(fen)末冶(ye)金(jin)钽(tan)靶材位(wei)置2的(de){110}占(zhan)比最大(da)为(wei)16.6%��,{100}占(zhan)比最(zui)小为11.70%�,相(xiang)差仅(jin)4.90%。
每个分(fen)析样(yang)各晶向(xiang)占(zhan)比如(ru)图5所示,从(cong)图(tu)5可(ke)以明(ming)显(xian)看出粉末冶(ye)金钽靶(ba)材(cai)的晶(jing)向(xiang)均匀性要远(yuan)好于轧(ya)制(zhi)钽靶(ba)材。比(bi)较不同(tong)分析样同(tong)种晶(jing)向(xiang)的占(zhan)比�,如(ru)图(tu)6所(suo)示,发(fa)现轧制钽靶(ba)材(cai){100}和(he){111}明(ming)显(xian)占(zhan)优,都远(yuan)高于粉(fen)末(mo)冶金钽(tan)靶材;而(er)粉(fen)末(mo)冶金钽(tan)靶(ba)材(cai)各(ge)晶(jing)向(xiang)占(zhan)比(bi)均匀(yun)��,2个(ge)样(yang)都(dou)只(zhi)有{110}占比会高(gao)于该面不(bu)占优(you)的(de)轧(ya)制(zhi)钽(tan)靶材。


统(tong)计分(fen)析(xi)4个分析(xi)样(yang)品的(de)平(ping)均(jun)晶粒(li),结(jie)果(guo)如表(biao)2和(he)图(tu)7所示。从图表中可(ke)以发现(xian),粉末(mo)冶(ye)金钽靶材(cai)的晶(jing)粒要小于(yu)轧(ya)制(zhi)钽靶材(cai)���,且粉(fen)末冶金(jin)钽靶材(cai)两(liang)个(ge)分析(xi)样(yang)的晶粒差(cha)值(zhi)不到(dao)7μm�����,小(xiao)于(yu)轧(ya)制钽(tan)靶(ba)材(cai)两(liang)个(ge)分(fen)析(xi)样(yang)的(de)差值(zhi)����,这(zhe)也一定(ding)程(cheng)度上(shang)说(shuo)明粉(fen)末冶(ye)金(jin)钽靶材晶(jing)粒均匀(yun)性(xing)可(ke)能会(hui)稍(shao)优于轧(ya)制(zhi)钽(tan)靶(ba)材(cai)���。

3、结论(lun)
(1)轧(ya)制(zhi)钽(tan)靶材不同(tong)取样位(wei)置(zhi)的晶(jing)向(xiang)差异(yi)较大,即便是(shi)同一个(ge)取样(yang)位(wei)置(zhi),整(zheng)个(ge)断面上���、中(zhong)、下的晶向(xiang)也存在不均匀(yun)现(xian)象。而(er)粉(fen)末(mo)冶(ye)金钽靶(ba)材不(bu)同(tong)取样位(wei)置的晶(jing)向比(bi)较(jiao)均(jun)匀(yun),同一(yi)个(ge)取(qu)样位置���,整(zheng)个断面的(de)上、中、下也(ye)相(xiang)对(dui)均匀一(yi)致(zhi)���。粉末冶金(jin)钽(tan)靶材(cai)晶(jing)向的均(jun)匀性要(yao)优(you)于(yu)轧制(zhi)钽靶(ba)材。
(2)轧(ya)制(zhi)钽(tan)靶材的晶(jing)粒(li)在(zai)90~103μm��,粉(fen)末(mo)冶(ye)金靶材(cai)的(de)晶粒(li)在54~62μm�����,轧制(zhi)钽(tan)靶材(cai)的(de)晶(jing)粒大于粉末(mo)冶(ye)金钽(tan)靶材。
(3)从晶粒(li)晶(jing)向(xiang)的(de)均匀性来(lai)说���,粉末(mo)冶(ye)金(jin)钽靶材要(yao)优于(yu)轧(ya)制(zhi)钽靶(ba)材(cai),粉(fen)末冶(ye)金(jin)工艺可(ke)能会成为14nm及以下(xia)技术节点(dian)集成(cheng)电(dian)路(lu)用(yong)钽(tan)靶材(cai)的(de)主要制(zhi)备技(ji)术(shu)。
参(can)考(kao)文献
[1]Michaluk A C .Correlating discrete orientation and grain size to the sputter deposition properties of tantalum[J].Journal of Elec-tronic Materials�,2002��,31(1):2-9.
[2]毛(mao)卫(wei)民���,杨(yang)平(ping),陈冷.材料织(zhi)构分析(xi)原(yuan)理与检(jian)测技(ji)术(shu)[M].北京:冶金(jin)工业(ye)出(chu)版社,2008.
[3]杨平.电(dian)子背散射衍射技(ji)术及(ji)其应用[M].北(bei)京(jing):冶金工业出版(ban)社(she),2007.
相(xiang)关(guan)链(lian)接