随(sui)着(zhe)激光�、离(li)子(zi)束等(deng)技术发展,研究人员(yuan)发明(ming)了多种(zhong)工(gong)艺制备(bei)氧化(hua)物薄(bao)膜材料,而磁控(kong)溅(jian)射(she)镀膜(mo)技术由(you)于(yu)其在大面积镀(du)膜(mo)以及(ji)性能(neng)参(can)数(shu)易调(diao)控(kong)上的优(you)势,成(cheng)为(wei)了工业(ye)及(ji)实(shi)验(yan)室(shi)镀(du)膜的主流方(fang)式(shi)。通(tong)过该技术可(ke)以(yi)制备(bei)出高(gao)性(xing)能(neng)氧化(hua)物薄膜�,以(yi)达到(dao)液晶屏(ping)、触(chu)摸(mo)屏(ping)、太阳(yang)能电(dian)池等(deng)领(ling)域的应(ying)用要(yao)求��。
在(zai)磁控溅(jian)射(she)技术中�,氧(yang)化(hua)物(wu)薄(bao)膜(mo)是通过(guo)电子(zi)与等离(li)子(zi)体(ti)轰击(ji)对应氧(yang)化物(wu)靶(ba)材(cai)进(jin)而(er)在基片上沉积获得(de)[1],因此薄(bao)膜(mo)各(ge)项性(xing)能(neng)与靶(ba)材(cai)质量息(xi)息(xi)相关(guan)。相比(bi)于(yu)通(tong)过金属(shu)靶(ba)材(cai)反应(ying)沉(chen)积(ji)成(cheng)膜���,直接(jie)使(shi)用氧(yang)化物靶材(cai)能(neng)减(jian)少靶(ba)材中(zhong)毒(du)�。氧(yang)化(hua)物靶材是(shi)陶瓷靶材的其(qi)中一种(zhong),随着光电器(qi)件产业(ye)的(de)发展(zhan)成为(wei)了一(yi)种(zhong)关键(jian)性基(ji)材(cai),但(dan)业界(jie)对其(qi)形状、组分等方(fang)面有(you)严格(ge)的应(ying)用
要求(qiu),靶(ba)材(cai)制备(bei)难(nan)度较(jiao)大(da)�。近年来(lai)我国靶材产(chan)业(ye)化取(qu)得了(le)很大进(jin)展(zhan),并涌(yong)出(chu)了多家具(ju)有(you)较强市场(chang)竞争(zheng)力的靶材厂(chang)商(shang),但在高端器件生产应用方面与(yu)日本��、德(de)国等国(guo)相(xiang)比(bi),我(wo)国(guo)氧(yang)化物(wu)靶材(cai)产业仍然(ran)是一大(da)短(duan)板(ban)。
目前(qian)����,氧(yang)化物(wu)靶(ba)材制(zhi)备以(yi)素(su)坯成型(xing)、烧(shao)结(jie)两(liang)大(da)工(gong)艺为主体���。本文(wen)以(yi)显示行(xing)业氧化(hua)物(wu)靶材(cai)作(zuo)为(wei)重点,结合(he)实(shi)验室研(yan)究(jiu)与工业(ye)生(sheng)产对(dui)靶材结构(gou)、性(xing)能(neng)需求,对(dui)两(liang)大(da)工(gong)艺分别(bie)进行(xing)分析����,并对(dui)目前(qian)氧化物(wu)靶材的市场(chang)现状与发展趋势(shi)进行了总结(jie)��。
1、氧化(hua)物靶(ba)材种(zhong)类(lei)与(yu)结构发展趋(qu)势(shi)
溅(jian)射(she)靶材(cai)的种(zhong)类繁多,按(an)照(zhao)应(ying)用(yong)领(ling)域(yu)可(ke)分为半导体(ti)相(xiang)关(guan)行(xing)业,以及磁记(ji)录����、光(guang)记录�、显示靶(ba)材(cai)等。
目(mu)前氧化(hua)物(wu)靶(ba)材(cai)主(zhu)要集中(zhong)在显(xian)示(shi)靶(ba)材(cai)领(ling)域�����,是制备显示面(mian)板(ban)中透明(ming)电极、半(ban)导(dao)体层与(yu)绝(jue)缘层(ceng)的主(zhu)要基材�����。随着近年来(lai)中(zhong)国新型显示(shi)产(chan)业的市(shi)场(chang)竞争(zheng)力不断攀升�����,作为(wei)全(quan)球最(zui)大 TFT-LCD 显(xian)示(shi)面(mian)板生产(chan)基地���,氧化(hua)物靶(ba)材也(ye)成(cheng)为(wei)了(le)国内(nei)的(de)研(yan)究(jiu)热点(dian)。对(dui)于(yu)显示(shi)面(mian)板领(ling)域(yu),ITO、AZO 等靶(ba)材溅(jian)射(she)得(de)到(dao)的(de)透明(ming)电(dian)极(ji)被(bei)产(chan)业(ye)界(jie)广(guang)泛采(cai)用(yong)�����。利(li)用(yong) ZnO、IZO、IGZO 等(deng)靶
材(cai) 溅 射(she) 得(de) 到(dao) 的 薄(bao) 膜(mo) 可 用(yong) 于 TFT 有(you) 源 层 ,在 LCD、OLED 等应(ying)用中显示(shi)出(chu)良好(hao)的(de)性能。此(ci)外,华(hua)南(nan)理工大学还(hai)开(kai)发出(chu)了(le)基(ji)于(yu)镧(lan)系(xi)稀土(tu)的新(xin)型(xing) Ln-IZO 靶材(cai)(图 1),突(tu)破了(le)国(guo)外(wai)传统 IGZO 材料体系的专利(li)限制(zhi),制备出(chu)的 TFT 器(qi)件(jian)可满(man)足(zu)驱动 AMOLED 的要(yao)求。为了(le)制(zhi)备高性(xing)能氧化(hua)物(wu)薄(bao)膜(mo)�����,除(chu)溅射(she)参(can)数外,对(dui)于(yu)靶(ba)材(cai)自(zi)身(shen)也(ye)有需(xu)求���,如(ru)高(gao)致密(mi)度(du)、组(zu)织均(jun)匀(yun)、大尺寸及(ji)异(yi)形(xing)化(hua)����。
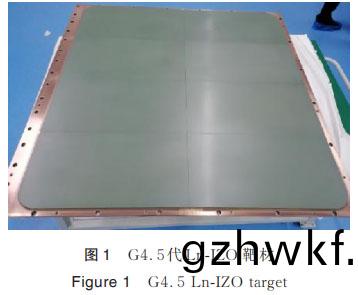
2、氧化(hua)物(wu)靶(ba)材(cai)制备工艺(yi)
氧化(hua)物靶(ba)材的制备(bei)流程�,通常(chang)包括(kuo)粉体合(he)成���、素(su)坯(pi)成(cheng)型(xing)及(ji)烧结(jie)三部分(图 2)��。制(zhi)备(bei)前(qian)期(qi)需(xu)要(yao)通(tong)过(guo)机(ji)械(xie)球(qiu)磨(mo)�����、化学(xue)共沉淀等(deng)方法���,将原材(cai)料化(hua)为细(xi)密的氧(yang)化物(wu)粉(fen)体(ti),然后(hou)利用成型(xing)工(gong)艺制(zhi)备(bei)出靶(ba)材(cai)素坯(pi)�,再将素坯(pi)进行(xing)烧(shao)结�,最后得到(dao)靶材成(cheng)品(pin)。

2.1 素坯成型(xing)
素坯的结构(gou)密(mi)度是影响最(zui)终(zhong)靶材(cai)致(zhi)密程(cheng)度(du)的关键因素(su),而成型(xing)方式会在很(hen)大(da)程度上决(jue)定(ding)了(le)素坯的(de)结构、气孔(kong)分(fen)布情况����。最(zui)为(wei)便(bian)利(li)的素坯成型(xing)方法为(wei)模(mo)压(ya)成(cheng)型[2],即(ji)先在(zai)模(mo)具中放(fang)入氧化(hua)物(wu)粉末��,然(ran)后(hou)压(ya)制出相应(ying)形(xing)状(zhuang)的(de)靶材(cai)素(su)坯。然而,当使(shi)用的(de)压(ya)力(li)过(guo)大时坯(pi)体(ti)不易(yi)脱(tuo)模,并且(qie)压制时(shi)由(you)于各(ge)方向压(ya)力不(bu)均(jun)�,制(zhi)得(de)的(de)素(su)坯(pi)容易(yi)产生局(ju)部(bu)开(kai)裂脱落(luo)���。在模(mo)压基(ji)
础(chu)上使用冷等(deng)静压成型(xing)(CIP)方(fang)法可有(you)效解(jie)决上述问题(ti)[3],即(ji)将(jiang)模压(ya)成(cheng)型(xing)后(hou)的(de)素坯放(fang)在弹性(xing)橡(xiang)胶套(tao)内����,随(sui)后(hou)置于(yu)以不(bu)可压(ya)缩(suo)流体(ti)填(tian)充(chong)的(de)密(mi)闭容(rong)器中(zhong)并对(dui)流(liu)体施加(jia)压(ya)力����,这样(yang)则(ze)可(ke)将压(ya)力均(jun)匀(yun)的传递至(zhi)素(su)坯(pi)���,坯(pi)体(ti)不会(hui)受(shou)到(dao)剪切(qie)应(ying)力(li)及(ji)摩擦力的(de)作用,故(gu)而(er)制得不易(yi)开裂(lie)且更(geng)为致(zhi)密的(de)素(su)坯���。中(zhong)南(nan)大(da)学刘(liu)志(zhi)宏(hong)等(deng)[4]发现(xian),在(zai)冷(leng)等(deng)静(jing)压工艺(yi)中(zhong)模压大(da)小(xiao)会影(ying)响(xiang)素(su)坯(pi)密度(du)(图(tu)3),合适的(de)模(mo)压能减少素坯颗粒间的空(kong)隙�����,当(dang)粉体在(zai)模压 24 MPa 下(xia)预成型后���,再在(zai) 250 MPa 下冷(leng)等(deng)静(jing)压(ya)�,可(ke)以制得相对密度(du) 59.3% 的素坯�����,最终经(jing)烧(shao)结(jie)得到(dao)相对密(mi)度(du) 99.1% 的 ITO 靶材(cai)�。采用冷等静压法可(ke)以制备出(chu)高(gao)品(pin)质 AZO��、ITO 及 IGZO 靶(ba)材的(de)素坯[5-7]�����,经(jing) 过(guo) 冷(leng) 等 静 压 处 理 后(hou) 的(de) 素 坯(pi) 更 为 致(zhi) 密 均匀(yun)[8-9],但对(dui)于(yu)大尺寸(cun)靶材(cai)时良品(pin)率(lv)较(jiao)低�,由于(yu)受(shou)到(dao)腔室尺寸的(de)限制(zhi),设(she)备(bei)投(tou)资昂(ang)贵����。

近(jin)年来(lai)���,将粉(fen)体制(zhi)成浆(jiang)料后(hou)再(zai)成型(xing)的(de)方法受到业界(jie)青(qing)睐(lai)[10-12]��,该工艺(yi)称为注浆(jiang)成(cheng)型。先(xian)将(jiang)氧(yang)化(hua)物粉体(ti)与(yu)溶剂混(hun)合�����,再(zai)加(jia)入分(fen)散(san)剂得(de)到具(ju)有(you)良好(hao)流动(dong)性的(de)浆料(liao)�,将(jiang)浆(jiang)料在一(yi)定压(ya)力(li)下(xia)注(zhu)入(ru)到(dao)具(ju)有强(qiang)吸(xi)水性(xing)的模(mo)具中,在(zai)其(qi)吸水(shui)作用(yong)下干燥固(gu)化(hua)得(de)到靶(ba)材素(su)坯(pi)��。该工艺目(mu)前被(bei)日本(ben)日矿、日本(ben)东(dong)曹(cao)、韩(han)国三星(xing)康宁(ning)等(deng)公司(si)采用����,使(shi)用(yong)该(gai)工艺(yi)生(sheng)产的高(gao)密(mi)度(du) ITO 靶材
在国(guo)际市场(chang)占有(you)率(lv)达(da)到(dao)一半(ban)以上(shang)[13]。在注浆成(cheng)型(xing)基(ji)础上还(hai)发展出(chu)了凝(ning)胶注(zhu)模(mo)[14-19]成(cheng)型(xing)技术,并(bing)广(guang)泛(fan)应(ying)用于(yu)高致(zhi)密陶(tao)瓷(ci)的制备(bei)(图 4[20])。该工艺同(tong)样通(tong)过(guo)将粉体制备成良好流(liu)动性的浆(jiang)料(liao)��,随后(hou)在(zai)其中(zhong)加(jia)入(ru)有(you)机单(dan)体(ti),固(gu)化(hua)后(hou)成型(xing)。此(ci)过(guo)程中有(you)机(ji)单(dan)体(ti)发(fa)生聚(ju)合反(fan)应,使(shi)得浆料(liao)中(zhong)的(de)颗(ke)粒(li)被(bei)固定(ding)并(bing)形(xing)成具有(you)三维结构(gou)的物质(zhi),脱(tuo)模后干(gan)燥并除(chu)去凝(ning)胶制备出均匀致(zhi)密(mi)素坯。杨硕等[21]研(yan)究(jiu)了凝(ning)胶注(zhu)模成型(xing)工(gong)艺(yi)中浆(jiang)料(liao)固相(xiang)含量的(de)适(shi)宜范(fan)围(wei)发现(xian)���,素坯密度(du)随固相含(han)量提(ti)升而增(zeng)大(图 5—6)�����,但是含量(liang)过高(gao)会导(dao)致(zhi)浆(jiang)料(liao)流动(dong)性变差����,难以(yi)进(jin)行浇(jiao)注(zhu)����。在注(zhu)浆成型和(he)凝胶注(zhu)模工(gong)艺中需(xu)要使用低(di)黏度(du)����、无杂(za)质且(qie)稳(wen)定(ding)的(de)浆料(liao),加(jia)上分散剂(ji)��、粘结(jie)剂(ji)等(deng)添(tian)加(jia)剂进(jin)行辅(fu)助�����,实际(ji)生产(chan)过(guo)程后(hou)期(qi)还需脱脂(zhi)工(gong)艺(yi)以减少添加剂等(deng)杂质残留(liu)���,这(zhe)两(liang)种(zhong)工(gong)艺(yi)操(cao)作较为简单��、成本低(di),并(bing)且(qie)能(neng)够满(man)足(zu)大尺寸及(ji)异形氧(yang)化物靶材的(de)制(zhi)备����,适(shi)用范(fan)围广(guang)���。


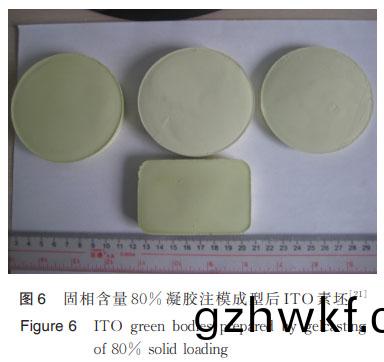
2.2 烧结(jie)工(gong)艺(yi)
素(su)坯成型(xing)后需(xu)进行(xing)烧(shao)结(jie) ,其中(zhong)热压(ya)法(HotPressed Sintering)是(shi)最为(wei)传统的(de)氧(yang)化(hua)物靶(ba)材(cai)烧结(jie)工艺(yi)�。热(re)压法(fa)是(shi)利用热能(neng)和机械(xie)能(neng)的共(gong)同作(zuo)用(yong)����,将(jiang)氧(yang)化(hua)物(wu)粉末(mo)或(huo)素坯(pi)烧(shao)结(jie)致(zhi)密化[2]。与(yu)素坯(pi)成(cheng)型中的模压法(fa)类似,热(re)压法(fa)是单轴(zhou)向(xiang)加(jia)压加热的(de)方(fang)式使坯(pi)体(ti)处(chu)于(yu)热(re)塑性(xing)状(zhuang)态(tai),施加高压时(shi)靶(ba)材烧结温(wen)度的下降(jiang)加快(kuai)了(le)坯(pi)体(ti)致密化。然(ran)而,热(re)压法效率低(di)且(qie)对模具有(you)较(jiao)高(gao)要求(qiu)��,导致整(zheng)体成(cheng)本高�、靶(ba)材(cai)晶(jing)粒不(bu)均(jun)、良品(pin)率(lv)低(di)�����。
利用热等静压(ya)法[22-23](Hot Isostatic Pressing)可以有(you)效提(ti)高靶(ba)材晶(jing)粒(li)均匀(yun)度(du)及(ji)致密(mi)度(du)。热等静(jing)压(ya)法与(yu)前面介(jie)绍的(de)冷等(deng)静压法(fa)相似�����,素坯在烧(shao)结(jie)时(shi)受到(dao)各方(fang)向(xiang)的压力(li)均匀,此过程(cheng)中晶粒的(de)生(sheng)长方向(xiang)均(jun)相(xiang)同,制得致(zhi)密(mi)均(jun)匀及异形(xing)的(de)氧(yang)化(hua)物靶(ba)材(cai)。使用热等静(jing)压工艺制(zhi)造的氧化(hua)物靶材(cai)质(zhi)量被业界广泛认可,如德(de)国莱(lai)博德公司的靶(ba)材是(shi)市面上质(zhi)量最(zui)好的(de)靶(ba)材(cai)之一[24]���。中南(nan)大(da)学张(zhang)树(shu)高[25]将粉体先在(zai) 200 MPa下冷(leng)等静(jing)压(ya),然后在 1000 ℃、保压(ya)压(ya)力(li) 128 MPa、保温时(shi)间(jian) 3 h 条(tiao)件(jian)下进行(xing)热等静压烧结,制得(de)的(de) ITO靶材(cai)密度(du)达(da)到(dao) 99.5%。华中(zhong)科技大(da)学的陈曙光[26]等以热(re)等(deng)静压(ya)方(fang)式成功制(zhi)备了密(mi)度(du)大(da)于(yu) 99.8% 的(de)圆柱形 ITO 靶材����。虽然热等静压(ya)法(fa)可(ke)提高靶材(cai)的致(zhi)密度(du)���,但(dan)是不足之(zhi)处(chu)在于(yu)生产(chan)制备(bei)氧化物靶(ba)材的(de)成本(ben)较髙��。
相(xiang)较于(yu)热(re)等(deng)静压(ya)法,由(you)于(yu)常压烧(shao)结工艺生产成(cheng)本(ben)低(di)而更(geng)适合工业(ye)化生产����。常压烧结(jie)法(fa)[27-29]是(shi)在一(yi)定气(qi)氛(fen)(如氮气(qi)、氧气和空(kong)气)和温(wen)度下(xia)对素(su)坯(pi)烧(shao)结(jie)的方法��。与(yu)前(qian)面(mian)两(liang)种烧(shao)结工艺(yi)不(bu)同,常压(ya)烧结不(bu)需要额(e)外加(jia)压(ya),一般是(shi)通过调节气氛和温度(du)来满足(zu)不(bu)同(tong)靶材的烧结(jie)需求。值(zhi)得一提(ti)的是(shi),素坯(pi)性质是影响(xiang)常(chang)压(ya)烧结靶(ba)材(cai)致(zhi)密化和(he)提高靶材的晶粒(li)质量及致
密(mi)度(du)的重(zhong)要(yao)因(yin)素(su)���。使用(yong)模压(ya)等(deng)简单(dan)成型方法制备出的(de)靶材素坯(pi),其坯(pi)体(ti)通常不(bu)够均(jun)匀致(zhi)密(mi),在(zai)使(shi)用常(chang)压(ya)烧结后容(rong)易(yi)出(chu)现开裂(lie)、密(mi)度(du)较(jiao)低(di)的(de)情况(kuang)。由(you)于(yu)受(shou)到(dao)素(su)坯(pi)成(cheng)型(xing)等(deng)工(gong)艺(yi)的限(xian)制,常(chang)压烧(shao)结(jie)法(fa)在(zai)早期基本(ben)无法满足氧(yang)化(hua)物靶(ba)材的制(zhi)备(bei)要求��,而随着(zhe)靶(ba)材(cai)素(su)坯成型工艺(yi)的发(fa)展��,如(ru)冷等静压�、凝胶注模等(deng)成(cheng)型技(ji)术的广泛应(ying)用���,常压(ya)烧结法(fa)成为了当下(xia)工业(ye)生产高(gao)质量(liang)
氧化物靶材(cai)的(de)主流烧(shao)结(jie)工艺�。孙(sun)文(wen)燕(yan)等(deng)[30]采(cai)用凝胶注(zhu)模(mo)成型技术(shu)制备 ZnO 陶(tao)瓷坯体���,并在较低温度(du)下常(chang)压烧结(jie)后(hou)获(huo)得相(xiang)对(dui)密度达(da) 98.6% 的 ZnO 靶(ba)材(cai)��,同(tong)时发现(xian)适度提高烧(shao)结温(wen)度可有效(xiao)增(zeng)加(jia)靶材(cai)相对(dui)密(mi)度(du)(图 7)。

目(mu)前(qian),日(ri)本(ben)日矿�、东(dong)曹(cao)等(deng)公司(si)在(zai)常压(ya)烧(shao)结方(fang)面(mian)拥(yong)有(you)明显(xian)的优(you)势(shi),日矿公司采(cai)用(yong)冷(leng)等静压法制(zhi)得(de)素(su)坯(pi),使用(yong)常(chang)压烧(shao)结法来(lai)生(sheng)产 ITO 靶(ba)材(cai),结果显(xian)示(shi)靶材(cai)致密(mi)且(qie)良(liang)品(pin)率(lv)高����;东曹(cao)公司使用(yong)注(zhu)浆成(cheng)型(xing)制(zhi)备 素(su) 坯(pi) �����,通 过 常 压(ya) 烧(shao) 结 能(neng) 制(zhi) 备 出 2200 mm×2500mm 的(de)大(da)尺寸(cun)靶材(cai)����,且(qie)其相对密(mi)度(du)高(gao)于(yu) 99.5%���。程(cheng)念等(deng)[31]研(yan)究了常(chang)压(ya)烧(shao)结 ITO 靶(ba)材时升温速(su)率对(dui)靶(ba)材(cai)密度及(ji)微观(guan)组(zu)织(zhi)的影响(xiang)发现��,在 1550 ℃氧(yang)气(qi)气(qi)氛(fen)下进(jin)行(xing)烧结(jie)时,在低(di)温(wen)阶(jie)段(duan)(0—500 ℃)升温(wen)速率为(wei)3 ℃·min−1,高 温 阶 段(500—1550 ℃)升(sheng) 温 速 率 为8 ℃·min−1的(de)条件下,可以得到(dao)相对(dui)密度(du)为 99.58%的(de)靶材(cai),其(qi)孔(kong)洞(dong)少(shao)且(qie)宏观上(shang)无裂纹(wen)。Chen 等(deng)[32]先将In2O3、Ga2O3和(he) ZnO 粉(fen)末(mo)研(yan)磨后进(jin)行冷(leng)等(deng)静(jing)压(ya)成(cheng)素(su)坯(pi),随后(hou)在氧气(qi)气(qi)氛(fen)下(xia)常压(ya)烧结(jie)制得了相对(dui)密度(du)99.13% 的(de) IGZO 靶(ba)材(cai),且(qie)元素(su)分(fen)布与微观(guan)结(jie)构均(jun)匀(图(tu) 8)�����。

与传(chuan)统(tong)常压(ya)烧结相比,先(xian)快速加热(re),然(ran)后(hou)在(zai)较低温度下保(bao)温一(yi)定时间(jian)的(de)两步烧(shao)结(jie)(TSS)制(zhi)备(bei)的(de)氧(yang)化(hua)物靶材晶(jing)粒尺寸(cun)更(geng)小、电(dian)阻(zu)率(lv)更(geng)低(di)、密度(du)更(geng)高���。
Liu 等(deng)[33]使用注浆成型(xing)制(zhi)得 IGZO 靶材素坯���,然(ran)后将(jiang)其(qi)快速(su)升(sheng)温(wen)至 1450 ℃,再(zai)降(jiang)至 1350 ℃并保(bao)温 12 h,最后(hou)得(de)到相(xiang)对(dui)密(mi)度 99.5%、平(ping)均(jun)晶粒尺(chi)寸 5.81 μm�����、电阻(zu)率(lv) 2.31 ×10−3 Ω·cm 的(de)高(gao)质(zhi)量 IGZO 靶材��,其溅射(she)薄(bao)膜在(zai)可见(jian)光(guang)范围(wei)内具(ju)有(you) 88% 透(tou)射(she)率,以及(ji)0.6—0.7 nm 的(de) 低 均(jun) 方(fang) 根(gen)(RMS)粗 糙 度 和 约(yue) 9×10−3 Ω·cm 的 低 电(dian) 阻 率 ���。 文(wen) 献[34-38]报(bao) 道 的(de) 非(fei) 晶IGZO-111 和(he) IGZO-112 溅射(she)薄(bao)膜的(de)电阻率范(fan)围分别为(wei) 5×10−3—1×104sup>Ω·cm 和 4×10−3—1×105 Ω·cm���,具体取(qu)决于溅射(she)参(can)数。但常压(ya)烧(shao)结(jie)要(yao)求(qiu)粉(fen)体(ti)具(ju)有(you)高烧结活性���,并(bing)需要(yao)加入(ru)各(ge)种(zhong)烧结助(zhu)剂(ji)[39-41]。
烧结(jie)工艺的(de)差(cha)异会(hui)在很大(da)程度上(shang)影(ying)响靶材(cai)的密度(du)、晶(jing)粒(li)尺(chi)寸��、化(hua)学(xue)组成(cheng)、电(dian)阻(zu)率(lv)等(deng)各项(xiang)参数[43]�����,进(jin)而(er)影响(xiang)溅(jian)射(she)薄(bao)膜(mo)的(de)性(xing)能����。氧化物(wu)靶材如(ru) ITO 在(zai)高(gao)温(wen)下(xia)可能(neng)会分(fen)解(jie)为低(di)价(jia)氧化物(In2O 或者(zhe) SnO)等(deng)物(wu)质(zhi)�,此(ci)过程会(hui)有(you)氧气释放(fang)形(xing)成气(qi)孔阻(zu)止(zhi)靶(ba)材(cai)的(de)致密化。华(hua)南(nan)理工(gong)大学(xue)兰林锋[44]等使用热(re)压(ya)法(fa)制备IZO 靶材(cai)时(shi)发(fa)现,烧(shao)结温(wen)度(du)为(wei) 850 ℃时(shi)靶(ba)材(cai)呈(cheng)致密(mi)化(hua)状(zhuang)态(tai)���,而(er)当温度升(sheng)至(zhi) 900 ℃后 In2O3的(de)挥(hui)发(fa)破(po)坏了(le)靶(ba)材(cai)烧结(jie)致(zhi)密化(hua)。Wu 等[43]研究(jiu)了摩尔(er)分(fen)数(shu)(In2O3∶Ga2O3∶ZnO)为(wei) 1∶1∶1 和(he) 1∶1∶2 的(de) IGZO 靶材(cai)发(fa)现,
当烧(shao)结(jie)温度(du)从(cong) 1400 ℃ 提高(gao)到 1500 ℃ 时,两(liang)种(zhong)靶材(cai)的(de)孔(kong)隙率都(dou)有(you)增加(jia),主(zhu)因(yin)是高(gao)温下 In2O3与(yu) ZnO 的挥发(fa)���,而延(yan)长(zhang)烧(shao)结时间也(ye)会(hui)破(po)坏靶材晶体(ti)结构,降低致密度(du)并使(shi)电(dian)阻(zu)率(lv)上升。
由于(yu)烧(shao)结(jie)时需(xu)要通(tong)入(ru)氧(yang)气或(huo)者空气维持(chi)一定(ding)的(de)氧压(ya),以阻(zu)止氧化(hua)物靶(ba)材(cai)的进一步(bu)分解(jie)[45]。优化烧(shao)结(jie)条(tiao)件能有效提(ti)高(gao)靶(ba)材密度并(bing)降(jiang)低(di)晶粒(li)尺(chi)寸�,使(shi)用(yong)较高(gao)密度(du)的氧化物靶材(cai)通常(chang)可以制备出(chu)较(jiao)低电(dian)阻(zu)率的薄(bao)膜[46]�����,此(ci)外薄(bao)膜的薄层电阻、透射率和(he)均匀性(xing)也(ye)受(shou)到晶(jing)粒(li)尺寸(cun)的(de)显(xian)着影(ying)响�。Xu 等(deng)[47]研(yan)究了烧(shao)结(jie)工(gong)艺(yi)对(dui) ITO 靶材的(de)晶粒(li)尺寸(cun)的影(ying)响发现(xian)�,快(kuai)速(su)加热(re)和(he)较短的(de)保(bao)温时间能(neng)得(de)到(dao)直(zhi)径(jing)小于 10 μm 的小晶(jing)粒(li)尺(chi)寸的(de)靶材(cai)�����,其(qi)在溅(jian)射(she)时(shi)膜(mo)厚波动(dong)小�,可以提(ti)高(gao)薄膜(mo)可(ke)见光透射率的均(jun)匀性、降(jiang)低平均薄(bao)层(ceng)电(dian)阻并(bing)提高薄(bao)层(ceng)电阻均匀性�����。SnO2均(jun)匀分(fen)布的(de) ITO 靶材����,可以抑(yi)制溅(jian)射过(guo)程中(zhong)的电(dian)弧现(xian)象(xiang)和结(jie)瘤(liu)的产生[48],同(tong)时(shi) ITO 薄(bao) 膜(mo) 中 的 锡(xi) 含 量(liang) 对 电 导 率 调 节(jie) 非(fei) 常 重要[49-50]����。 在 Xu[51]的(de) 一(yi) 项(xiang) 研 究(jiu) 中 发(fa) 现(xian) ����,ITO 靶(ba) 材 中(zhong)SnO2含量的降低(di)会(hui)导致靶(ba)材(cai)电阻率(lv)上升(sheng)�,而弯曲强(qiang)度 和 密 度 下 降 ���。 Minami[52]和 Huang[53]等 研(yan) 究 了(le)AZO 靶材的(de)电(dian)性(xing)能(neng)对溅(jian)射(she)薄(bao)膜(mo)性(xing)能(neng)的影(ying)响(xiang),结果(guo)表(biao)明具有较(jiao)低(di)电阻(zu)率的(de) AZO 靶(ba)材可制(zhi)备更(geng)低电(dian)阻(zu)率(lv)且(qie)电(dian)阻率空(kong)间分(fen)布(bu)更(geng)均匀(yun)的薄膜。目前(qian),报道[54-59]的 常 压(ya) 烧 结 法 制 备 的(de) AZO 靶(ba) 材 的(de) 相 对(dui) 密(mi) 度 为98.6%—99.8%、晶(jing)粒尺(chi)寸(cun)为(wei) 2.7—5.0 μm 和电阻率范(fan)围(wei) 8.9×10−4—0.5 Ω·cm。Chen 等(deng)[60]研究(jiu)了烧(shao)结(jie)温(wen)度(du)对(dui) Ti 掺(can)杂(za) ZnO(TZO)陶(tao)瓷靶材及其薄膜(mo)的影(ying)响发(fa)现,在(zai) 1300 ℃ 烧结(jie)的(de)靶材(cai)溅射(she)的薄(bao)膜(mo)相对(dui)光(guang)滑,并且(qie)具(ju)有较高的(de)透(tou)光(guang)率(lv)(88.9%)和较(jiao)低(di)的(de)电(dian)阻率(lv)(8.47×10−4 Ω·cm)����。通过(guo)使用(yong) TiO2-x 靶(ba)材可直流(liu)溅(jian)射制备 TNO 薄膜(mo)��,其(qi)电阻(zu)率约(yue)为(wei) 1.3×10−3 Ω·cm����,在(zai)可见光(guang)范围的透(tou)射率(lv)达到 70%[61]���。
3、结语
氧化物陶瓷(ci)靶材是当下溅(jian)射(she)靶(ba)材(cai)行(xing)业(ye)中的(de)研(yan)究(jiu)热点(dian)���,是制备高性能(neng)氧化(hua)物功能(neng)薄膜的(de)关(guan)键(jian)基(ji)材。随(sui)着磁(ci)控(kong)溅射镀膜技术(shu)的发(fa)展(zhan)���,氧(yang)化物(wu)靶材(cai)逐渐(jian)向(xiang)大(da)尺(chi)寸(cun)、异形(xing)化(hua)、高(gao)致(zhi)密方(fang)向(xiang)发(fa)展(zhan)。素(su)坯(pi)成(cheng)型及(ji)烧(shao)结(jie)的(de)工(gong)艺是靶(ba)材(cai)制(zhi)备(bei)工序中的关键环节(jie)����,二者(zhe)的(de)工艺在很大程度上决定了靶(ba)材的品质及(ji)生(sheng)产成(cheng)本(ben)。近年来(lai)�����,半导(dao)体器(qi)件(jian)产业在我(wo)国国民经(jing)济(ji)的(de)比重不(bu)断提升(sheng),其(qi)中显示面(mian)板产(chan)业的(de)迅速(su)发(fa)展不断牵(qian)动着(zhe)上(shang)游装备(bei)制(zhi)造与光(guang)电材(cai)料技术突破��。然而(er)掌握(wo)先进氧(yang)化(hua)物靶(ba)材(cai)制(zhi)备工艺(yi)的国家大多实行(xing)技术(shu)封(feng)锁,国(guo)内(nei)各厂商(shang)生(sheng)产(chan)的靶(ba)材质量将在(zai)很(hen)长(zhang)一(yi)段(duan)时间(jian)内(nei)都(dou)无法满足高端(duan)显(xian)示面(mian)板产业(ye)的需求(qiu)���,我国(guo)氧化物(wu)靶材依(yi)赖(lai)进口[62]。而(er) ITO、AZO、ZnO���、IGZO 等氧(yang)化物靶(ba)材作为(wei)生(sheng)产高(gao)性能导(dao)电薄膜(mo)的关键(jian)原料(liao),其(qi)产业(ye)化(hua)对(dui)于(yu)我国摆脱(tuo)国(guo)外上(shang)游(you)配套(tao)原料(liao)垄(long)断(duan)具有(you)重要意义(yi)。
鼓励支持(chi)我国(guo)本土靶材生(sheng)产企业研(yan)发(fa)氧(yang)化物陶(tao)瓷靶材(cai),必(bi)将(jiang)会给半(ban)导体器件产(chan)业带(dai)来新的发(fa)展机遇����。
参考(kao)文(wen)献:
[1]陈海(hai)峰(feng)���,薛莹洁(jie) .国内外磁控溅(jian)射(she)靶(ba)材(cai)的(de)研(yan)究(jiu)进(jin)展[J].表面(mian)技(ji)术(shu),2016,45(10):56-63.
[2]童(tong)义平(ping),赖秀红(hong),黄秀(xiu)娟(juan) .AZO 超高(gao)致密(mi)度化(hua)工艺(yi)研(yan)究(jiu)[J].中(zhong)国(guo)陶瓷(ci)工业���,2013���,20(2):8-10.
[3]鲁(lu)燕萍(ping) .陶(tao)瓷冷等静(jing)压(ya)成(cheng)型技(ji)术(shu)[J].真空电子(zi)技(ji)术,2011(4):31-34.
[4]刘志宏(hong),谌(chen)伟(wei),李(li)玉虎��,等 .成(cheng)型压(ya)力(li)对(dui)冷(leng)等(deng)静(jing)压(ya)-烧结法制备 ITO 靶(ba)材(cai)中孔隙(xi)缺(que)陷的影响[J].中(zhong)国(guo)有色(se)金(jin)属(shu)学(xue)报(bao),2015,25(9):2435-2444.
[5]张明(ming)杰,陈(chen)敬(jing)超(chao)���,彭(peng)平(ping)�����,等 .不(bu)同(tong)冷等(deng)静(jing)压压(ya)力(li)对 ITO 靶材性能影响的研究[J].化工新(xin)型材(cai)料����,2015,43(5):117-119.
[6]单静(jing)静 .氧(yang)化(hua)镓(jia)粉(fen)体及其高致(zhi)密靶(ba)材的制备(bei)研(yan)究(jiu)[D].武(wu)汉:华(hua)中科技大学����,2018.
[7]刘(liu)斌,马瑞(rui)新(xin)����,邵伟(wei)�,高贵华(hua) .氧(yang)化(hua)锌(xin)铝溅(jian)射(she)靶(ba)材及(ji)其薄膜的(de)制(zhi)备[M].北京:中(zhong)国(guo)学术(shu)期(qi)刊(kan)电子(zi)出版(ban)社(she),2005:424-427.
[8]大桥建夫,熊原吉一(yi) .铟锡氧(yang)化(hua)物(wu)溅射(she)靶:CN1365398[P].2002-08-21.
[9]卢(lu)信冲,谢(xie)志(zhi)铭���,陈逸杰,等 .溅(jian)镀靶材的(de)制(zhi)造(zao)方(fang)法(fa):CN101045986[P].2007-10-03.
[10]钟(zhong)景(jing)明(ming)�,岳(yue)坤,孙本双,等(deng) .粉浆浇(jiao)注(zhu)制备大(da)尺(chi)寸 ITO 靶(ba)材工艺(yi)[J].中(zhong)国(guo)有色(se)金属学(xue)报,2014�����,24(9):2333-2338.
[11]周(zhou)贤(xian)界�����,惠(hui)浩 .高性(xing)能氧(yang)化(hua)物(wu)陶瓷靶(ba)材的压力(li)注(zhu)浆成(cheng)型(xing)工艺及(ji)应(ying)用[J].电(dian)工(gong)材料(liao),2015(3):34-38.
[12]孙(sun)宜华(hua) .AZO 透(tou)明导(dao)电氧(yang)化(hua)物(wu)靶(ba)材及(ji)其(qi)薄(bao)膜制备(bei)的研究[D].武(wu)汉(han):华中(zhong)科技大学(xue)���,2009.
[13]王(wang)松(song)�����,谢(xie)明(ming),王塞北(bei)��,等 .高(gao)密度氧(yang)化(hua)铟锡(xi)(ITO)靶材(cai)制(zhi)备(bei)工(gong)艺(yi)的研(yan)究(jiu)进(jin)展(zhan)[J].材料导报(bao),2013,27(S1):207-210.
[14]邵(shao)庄(zhuang)����,余柄峰 .凝胶注模(mo)法制(zhi)备(bei)多(duo)孔氧化铝(lv)陶(tao)瓷(ci)的研究(jiu)[J].中国陶(tao)瓷(ci)����,2007(10):50-52.
[15]周(zhou)东(dong)祥(xiang)���,欧(ou)阳(yang)俊(jun),郑(zheng)志平(ping),等 .微(wei)波陶瓷(ci)凝(ning)胶注(zhu)模(mo)成(cheng)型(xing)工(gong)艺研究[J].压(ya)电与声(sheng)光,2005(6):685-687.
[16]JIA C�,LIU W,GUO Z.Application of the gel castingprocess in iron powder metallurgy[J].Journal of University of Science and Technology Beijing,Mineral,Metallurgy����,Material�����,2006,13(1):29-33.
[17]GUO D,CAI K,LI L��,et al.Application of gelcasting tothe fabrication of piezoelectric ceramic parts[J].Journal of the European Ceramic Society,2003,23(7):1131-1137.
[18]杨硕(shuo),张秀(xiu)勤(qin),王政(zheng)红(hong),等(deng) .一种凝(ning)胶注(zhu)模(mo)成(cheng)型(xing)技术制备(bei)ITO靶(ba)材(cai)的方法:CN102432282B[P].2013-06-19.
[19]王科 .氧化(hua)铟锡(xi)陶(tao)瓷的凝(ning)胶(jiao)注(zhu)模成(cheng)型(xing)工(gong)艺(yi)研究(jiu)[D].长(zhang)沙:中南(nan)大(da)学,2014.
[20]MONTANARO L, COPPOLA B��, PALMERO P,et al.A review on aqueous gelcasting:A versatile and low-toxic technique to shape ceramics[J].Ceramics
International,2019�����,45(7):9653-9673.
[21]杨(yang)硕,刘(liu)冠鹏(peng)�,张(zhang)秀(xiu)勤,等 .凝胶注(zhu)模(mo)技(ji)术制(zhi)备(bei)高(gao)密度ITO 靶(ba) 材 的 研(yan) 究(jiu)[J].稀(xi) 有(you) 金(jin) 属(shu) 材 料(liao) 与(yu) 工(gong) 程(cheng) �,2012�����,41(S2):312-315.
[22]马福(fu)康 .等(deng)静压(ya)技术(shu)[M].北(bei)京(jing):冶金(jin)工(gong)业(ye)出(chu)版(ban)社����,1992.
[23]WEIGERT M����,KONIETZKA U,GEHMAN B.Target for cathode sputtering and method of its production:US480531[P].1996-1-2.
[24]董(dong)雪振,吴(wu)任平 .铝掺(can)杂(za)氧化锌(xin)(AZO)废(fei)弃(qi)靶材回收(shou)再(zai)利(li)用的(de)研究[J].材(cai)料导报(bao)���,2015,29(2):105-109.
[25]张(zhang)树高����,扈百直,吴义成(cheng)���,等(deng) .铟锡氧化(hua)物陶(tao)瓷靶材(cai)热(re)等(deng)静(jing)压致(zhi)密(mi)化(hua)研究[J].功(gong)能(neng)材料,2000(4):383-387.
[26]陈曙(shu)光 .铟锡(xi)氧化物(wu)(ITO)粉体及(ji)高性(xing)能(neng) ITO 靶(ba)材(cai)的(de)制(zhi)备(bei)与(yu)研(yan)究(jiu)[D].武汉:华中(zhong)科(ke)技(ji)大学����,2005.
[27]GEHMAN B L,JONSSON S,RUDOLPH T�,et al.Influence of manufacturing process of indium tin oxide sputtering targets on sputtering behavior[J].Thin SolidFilms�����,1992,220(1):333-336.
[28]KIM B,LEE J��,KIM J,et al.Rapid rate sintering ofnanocrystalline indium tin oxide ceramics:particle size effect[J].Materials Letters����,2002��,52(1):114-119.
[29]KIM S,SEO K,LEE J�,et al.Preparation and sintering of nanocrystalline ITO powders with different SnO2 content[J].Journal of the European Ceramic Society���,2006�����,26(1):73-80
[30]孙(sun)文(wen)燕�,王(wang)日初(chu)�,王(wang)小(xiao)锋(feng)���,等 .常(chang)压(ya)烧结法制(zhi)备 ZnO 陶(tao)瓷(ci)靶材(cai)[J].中(zhong)国有色(se)金属学报(bao),2015�,25(6):1625-1633.
[31]程念(nian)��,刘(liu)家祥(xiang) .升(sheng)温速率对(dui)烧(shao)结(jie) ITO靶(ba)材(cai)密度(du)和组(zu)织的(de)影(ying)响[J].稀有金(jin)属(shu)材(cai)料(liao)与工程,2013��,42(4):857-860.
[32]CHEN J,ZHONG J,LUO W,et al.Study on powder preparation of IGZO target and its effect on sintering[J].Journal of Alloys and Compounds,2019,800:468-477.
[33]LIU Y,SUN B,SHU Y,et al.Preparation of superior IGZO ceramics by two-step sintering for application in IGZOthin film fabrication[J].Journal of Materials Research andTechnology,2020����,9(3):5331-5342.
[34]JUNG C H,KANG H I,YOON D H.The electrical,optical, and structural properties of amorphous indiumgallium zinc oxide films and channel thin-film transistors[J].Solid-State Electronics,2013�����,79:125-129.
[35]LEE Y,DAI Z����,LIN C��,et al.Relationships between the crystalline phase of an IGZO target and electrical properties of a-IGZO channel film[J].Ceramics International,2012�,38:S595-S599.
[36]GADRE M J���,ALFORD T L.Highest transmittance and highmobility amorphous indium gallium zinc oxide films on flexible substrate by room-temperature deposition and post-depositionanneals[J].Applied Physics Letters,2011���,99(5):51901.
[37]AOI T�,OKA N�,SATO Y,et al.DC sputter deposition of amorphous indium-gallium-zinc-oxide(a-IGZO)films with H2O introduction[J].Thin Solid Films,2010,518(11):3004-3007.
[38]DU AHN B��,SHIN H S,KIM G H,et al.A novel amorphous InGaZnO thin film transistor structure without source/drain layer deposition [J].Japanese Journal of Applied Physics���,2009,48(3S2):3B-19B.
[39]SHIN Y, KANG S, LEE S, et al.Near infra-red transparent Mo-doped In2O3 by hetero targets sputtering for phosphorescent organic light emitting diodes[J].Organic Electronics����,2013,14(3):926-933.
[40]冉(ran)绍(shao)兵(bing),樊(fan)刚(gang)�����,张家涛 .Nd 掺(can)杂(za)对 ITO 粉(fen)体性能(neng)的(de)影(ying)响[J].功能(neng)材料与(yu)器(qi)件(jian)学(xue)报(bao)�,2007(5):476-480.
[41]MURAOKA M�, SUZUKI M�, SAWADA Y, et al.Sintering of tin-doped indium oxide (Indium-Tin-Oxide,ITO)with Bi2O3 additive[J].Journal of Materials Science���,1998,33(23):5621-5624.
[42]CHEN J,ZHONG J,LUO W,et al.Study on powder preparation of IGZO target and its effect on sintering[J].Journal of Alloys and Compounds����,2019,800:468-477.
[43]WU M,CHANG S,CHAUNG W��,et al.Preparation and sintering of indium-gallium-zinc oxide ceramics with different zinc oxide contents[J].Journal of the European Ceramic Society�����,2015,35(14):3893-3902.
[44]宋(song)二(er)龙(long),兰(lan)林锋,林(lin)振国,等(deng).热压烧结(jie)靶材(cai)制(zhi)备(bei)氧(yang)化铟(yin)锌(xin)薄膜(mo)晶体管(guan)[J].物理(li)化学(xue)学(xue)报��,2017����,33(10):2092-2098.
[45]KIM B, LEE J�����, KIM J, et al.Densification of nanocrystalline ITO powders in fast firing: Effect of specimen mass and sintering atmosphere[J].Materials
Research Bulletin,2005���,40(2):395-404.
[46]UTSUMI K,MATSUNAGA O��,TAKAHATA T.Low resistivity ITO film prepared using the ultra high density ITO target[J].Thin Solid Films,1998����,334(1):30-34.
[47]XU J,YANG Z,ZHANG X��,et al.Grain size control in ITO targets and its effect on electrical and optical properties of deposited ITO films[J].Journal of Materials Science:Materials in Electronics,2014���,25(2):710-716.
[48]OMATA T�����,KITA M,OKADA H,et al.Characterization of indium – tin oxide sputtering targets showing various densities of nodule formation[J].Thin Solid Films,2006,503(1):22-28.
[49]UNTILA G G,KOST T N,CHEBOTAREVA A B�����,et al.Effect of the tin content on the composition and optical and electrical properties of ITO films deposited onto siliconand glass by ultrasonic spray pyrolysis[J].Semiconductors�,2012�����,46(7):962-968.
[50]BISWAS P K,DE A,ORTNER K,et al.Study of sol-gelderived high tin content indium tin oxide(ITO) films on silica-coated soda lime silica glass[J].Materials Letters,2004��,58(10):1540-1545.
[51]XU J,YANG L,WANG H,et al.Sintering behavior and refining grains of high density tin doped indium oxide targets with low tin oxide content[J].Journal of Materials Science:Materials in Electronics����,2016����,27(4):3298-3304.
[52]MINAMI T,ODA J���,NOMOTO J,et al.Effect of target properties on transparent conducting impurity-doped ZnO thin films deposited by DC magnetron sputtering[J].Thin Solid Films,2010��,519(1):385-390.
[53]HUANG H S,TUNG H C,CHIU C H���,et al.Highly conductive alumina-added ZnO ceramic target prepared by reduction sintering and its effects on the properties of deposited thin films by direct current magnetron sputtering [J].Thin Solid Films�,2010�,518(21):6071-6075.
[54]HUANG H S�����,TUNG H C,CHIU C H�����,et al.Highly conductive alumina-added ZnO ceramic target prepared by reduction sintering and its effects on the properties of deposited thin films by direct current magnetron sputtering [J].Thin Solid Films,2010����,518(21):6071-6075.
[55]WEI T,ZHANG Y,YANG Y,et al.Effects of ZnAl2O4 segregation in high temperature sintered Al-doped ZnO sputtering target on optical and electrical properties of deposited thin films[J].Surface and Coatings Technology���,2013,221:201-206.
[56]ZHANG J,ZHANG W���,ZHAO E,et al.Study of highdensity AZO ceramic target [J].Materials Science in Semiconductor Processing���,2011,14(3):189-192.
[57]WU M,LIU D���,SU Y.The densification����,microstructure���,and electrical properties of aluminum-doped zinc oxide sputtering target for transparent conductive oxide film[J].Journal of the European Ceramic Society��,2012,32(12):3265-3275.
[58]LIU C P,JENG G R.Properties of aluminum doped zinc oxide materials and sputtering thin films[J].Journal of Alloys and Compounds,2009,468(1):343-349.
[59]LIU J,ZHANG W,SONG D,et al.Comparative study of the sintering process and thin film sputtering of AZO�,GZO and AGZO ceramics targets[J].Ceramics International���,2014�,40(8):12905-12915.
[60]CHEN Z��,LI F,CHEN X,et al.Influence of sintering temperatures of ceramic targets on microstructures and photoelectric properties of titanium-doped ZnO nano-films [J].Journal of Materials Science:Materials in Electronics���,2017�����,28(6):4654-4660.
[61]SATO Y, AKIZUKI H����, KAMIYAMA T���, et al.Transparent conductive Nb-doped TiO2 films deposited by direct-current magnetron sputtering using a TiO2-x target[J].Thin Solid Films���,2008,516(17):5758-5762.
[62]杨扬����,王(wang)振(zhen)华,谢(xie)梦(meng) .国(guo)内氧化(hua)铟(yin)锡靶材(cai)厂(chang)商(shang)的机遇与挑战(zhan)[J].新材料产业,2020(2):54-57.
相(xiang)关(guan)链(lian)接